來(lái)源:網(wǎng)絡(luò)
近日,微軟首席執(zhí)行官薩提亞·納德拉(Satya Nadella)在社交平臺(tái)上宣布,其團(tuán)隊(duì)已成功開(kāi)發(fā)出微流體冷卻技術(shù)——通過(guò)細(xì)如發(fā)絲的微小通道,直接將冷卻液輸送到芯片內(nèi)部。

人工智能的高速發(fā)展帶來(lái)前所未有的算力需求,而支撐這些需求的核心是數(shù)據(jù)中心里的高性能芯片。與以往的硅芯片相比,新一代AI芯片在功率和熱流密度上成倍提升,隨之而來(lái)的就是 更嚴(yán)重的發(fā)熱問(wèn)題。對(duì)于數(shù)據(jù)中心來(lái)說(shuō),這個(gè)問(wèn)題更為嚴(yán)峻。
“微流體冷卻能夠支持更高功率密度的設(shè)計(jì),從而在更小的空間內(nèi)實(shí)現(xiàn)客戶關(guān)心的功能并提供更好的性能。” 微軟云運(yùn)營(yíng)與創(chuàng)新部門(mén)企業(yè)副總裁兼首席技術(shù)官Judy Priest 表示。“但首先我們必須證明這項(xiàng)技術(shù)和設(shè)計(jì)可行,然后接下來(lái)的重點(diǎn)就是測(cè)試可靠性。”
實(shí)驗(yàn)室測(cè)試結(jié)果顯示,微流體冷卻在不同工作負(fù)載和配置下,散熱性能最高可比冷板提升三倍,并可使 GPU 芯片內(nèi)部的最高溫升降低 65%(具體數(shù)值隨芯片類型不同而變化)。團(tuán)隊(duì)預(yù)計(jì),這項(xiàng)先進(jìn)的冷卻技術(shù)還將改善數(shù)據(jù)中心的 PUE(電源使用效率) 指標(biāo),降低能耗和運(yùn)營(yíng)成本。
01 詳解微軟的微流體冷卻技術(shù)——從自然啟發(fā)到AI優(yōu)化
為了突破冷板液冷的局限,微軟研發(fā)團(tuán)隊(duì)嘗試了一種更激進(jìn)的方案:微流體冷卻(Microfluidics)。這項(xiàng)技術(shù)的核心思路,是直接在硅芯片背面蝕刻出微米級(jí)的溝槽,讓冷卻液能夠直接流經(jīng)發(fā)熱區(qū)域,而不是隔著多層封裝進(jìn)行散熱。
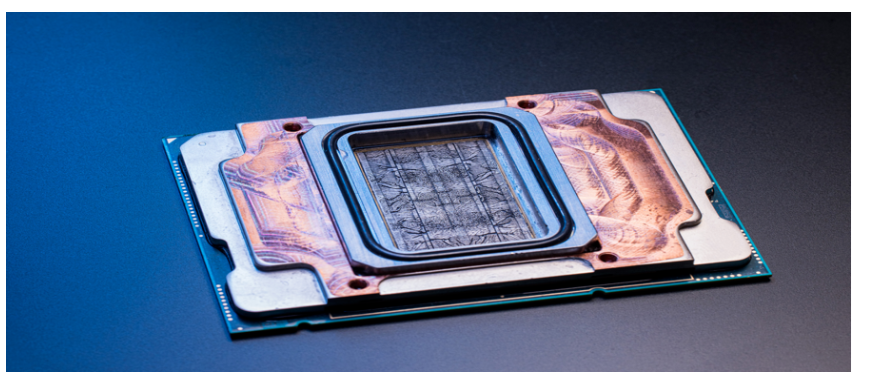
這些微通道的尺度接近頭發(fā)絲,極其精細(xì),稍有偏差就可能導(dǎo)致堵塞或芯片強(qiáng)度下降。因此,微軟團(tuán)隊(duì)與瑞士的初創(chuàng)公司(Corintis)合作在設(shè)計(jì)過(guò)程中引入AI輔助優(yōu)化,借助仿生學(xué)思路,讓冷卻液的流動(dòng)路徑更接近自然界中的高效分布。比如葉脈、蝴蝶翅膀的血管結(jié)構(gòu),它們都能以最短路徑輸送能量,AI 則幫助把這種“自然智慧”遷移到芯片的溝槽布局中,從而更精準(zhǔn)地冷卻“熱點(diǎn)”。
該技術(shù)需要確保通道足夠深,以循環(huán)足夠的冷卻液而不會(huì)堵塞,同時(shí)又不會(huì)太深以至于影響硅片有破裂的風(fēng)險(xiǎn)。僅在過(guò)去一年中,該團(tuán)隊(duì)就進(jìn)行了四次設(shè)計(jì)迭代。微流控還需要為芯片設(shè)計(jì)防漏封裝,找到最佳冷卻劑配方,測(cè)試不同的蝕刻方法,并開(kāi)發(fā)一種在芯片制造中添加蝕刻的精細(xì)化工藝。
實(shí)驗(yàn)表明,這種設(shè)計(jì)能讓冷卻性能相比冷板提升多達(dá)三倍,并使GPU內(nèi)部最高溫度降低約 65%。更重要的是,由于冷卻液能直接接觸硅芯片,所需的液體溫度不必像傳統(tǒng)冷板那樣過(guò)低,這意味著制冷能耗也同步下降,從而提高了數(shù)據(jù)中心的能源利用效率(PUE),降低運(yùn)維成本。
在應(yīng)用層面,微流體冷卻不僅能解決過(guò)熱問(wèn)題,還能為數(shù)據(jù)中心與AI計(jì)算帶來(lái)新的可能性:
性能釋放:支持更高功率、更高密度的芯片設(shè)計(jì),允許安全“超頻”。
可靠性提升:溫度控制更精確,降低芯片損傷風(fēng)險(xiǎn)。
空間效率:服務(wù)器機(jī)架可更緊湊布置,減少數(shù)據(jù)中心對(duì)新建筑的依賴。
可持續(xù)性:冷卻液無(wú)需過(guò)度降溫,同時(shí)還能提高余熱利用價(jià)值,降低對(duì)電網(wǎng)的負(fù)擔(dān)。
可以說(shuō),微流體冷卻并不僅僅是一種散熱手段,它更像是一種打開(kāi)未來(lái)芯片架構(gòu)和數(shù)據(jù)中心設(shè)計(jì)的新鑰匙。下一步,Microsoft繼續(xù)研究如何將微流體冷卻整合到其未來(lái)幾代第一方芯片中。該公司表示,它還將繼續(xù)與合作伙伴合作將微流體技術(shù)引入其數(shù)據(jù)中心的生產(chǎn)。
微流體冷卻只是微軟推動(dòng)下一代冷卻技術(shù)、優(yōu)化云堆棧各個(gè)環(huán)節(jié)的一部分。傳統(tǒng)數(shù)據(jù)中心依靠大型風(fēng)扇吹風(fēng)散熱,但液體的導(dǎo)熱效率遠(yuǎn)高于空氣。微軟已在數(shù)據(jù)中心部署的一種液冷形式就是冷板(cold plates):冷板置于芯片之上,冷卻液流入冷板內(nèi)部的通道,從芯片帶走熱量后再流出降溫。然而,芯片在封裝時(shí)會(huì)被多層材料覆蓋,用于擴(kuò)散熱量和保護(hù)芯片。但這些材料也限制了冷板的散熱效果。未來(lái)為 AI 設(shè)計(jì)的新一代芯片功率更強(qiáng),發(fā)熱更高,冷板將難以勝任。
通過(guò)微流體通道直接冷卻芯片效率更高,不僅能更快帶走熱量,還能提升整體系統(tǒng)性能。因?yàn)槿サ袅硕鄬痈魺岵牧希?span textstyle="" style="color: rgb(248, 14, 4);font-weight: bold;">冷卻液可以直接接觸發(fā)熱點(diǎn),因此不必保持極低溫度就能實(shí)現(xiàn)良好散熱。這意味著數(shù)據(jù)中心可以減少冷卻液制冷能耗,同時(shí)比冷板效果更好。微流體還支持更高效的廢熱利用。微軟還希望通過(guò)軟件等手段優(yōu)化數(shù)據(jù)中心運(yùn)營(yíng)。“如果微流體冷卻能減少冷卻能耗,就能減輕對(duì)附近社區(qū)電網(wǎng)的壓力。散熱還限制了數(shù)據(jù)中心設(shè)計(jì)。數(shù)據(jù)中心的優(yōu)勢(shì)之一是服務(wù)器可以緊密放置,但服務(wù)器間距過(guò)小就會(huì)出現(xiàn)散熱瓶頸。微流體冷卻將允許更高密度的服務(wù)器布局,從而在不擴(kuò)建新建筑的前提下提升算力。
微流體冷卻還可能為全新芯片架構(gòu)打開(kāi)大門(mén),例如3D堆疊芯片。就像把服務(wù)器靠近能降低延遲一樣,將芯片垂直堆疊能進(jìn)一步降低延遲。但這種3D架構(gòu)因發(fā)熱嚴(yán)重而難以實(shí)現(xiàn)。然而,微流體能夠?qū)⒗鋮s液帶到極靠近功耗的位置,因此完全可能在3D 芯片設(shè)計(jì)中讓冷卻液穿過(guò)芯片。比如采用柱狀微針作為層間支撐(類似多層車庫(kù)的柱子),讓冷卻液在其間流動(dòng)。
去除散熱瓶頸還將允許在服務(wù)器機(jī)架內(nèi)放置更多芯片,或在單芯片上集成更多核心,從而提升速度,并實(shí)現(xiàn)更小巧但更強(qiáng)大的數(shù)據(jù)中心。微軟希望通過(guò)證明像微流體這樣的新型冷卻技術(shù)可行,為全行業(yè)鋪平道路,使下一代芯片更高效、更可持續(xù)。
03 關(guān)于微流控
隨著半導(dǎo)體進(jìn)入三維結(jié)構(gòu),集成冷卻的想法逐漸可行。1980年代,制造商嘗試在硅芯片上疊加多個(gè)組件,并提出在上層制作微通道冷卻,但由于芯片供應(yīng)商更關(guān)注堆疊有源組件,這一方案未被廣泛采用。2015年,佐治亞理工學(xué)院與英特爾合作,首次在 FPGA 芯片上集成微流體冷卻層,將液體冷卻距離晶體管僅幾百微米,消除了硅芯片頂部散熱器的需求,為新一代電子產(chǎn)品提供了潛在顛覆性技術(shù)。
2020年,比利時(shí)魯汶大學(xué)的 Tiwei Wei 在電力電子領(lǐng)域提出微冷卻通道方案,主要針對(duì) GaN 等大功率芯片,盡管他認(rèn)為該技術(shù)不適合通用微處理器。同時(shí),瑞士洛桑聯(lián)邦理工學(xué)院的 Matioli 團(tuán)隊(duì)在晶體管下方構(gòu)建微流體 3D 網(wǎng)絡(luò),使冷卻液直接接近發(fā)熱核心,功率密度可達(dá)每平方厘米 1.7kW,顯著提高散熱效率。
2021年,微軟團(tuán)隊(duì)將微針鰭片蝕刻在標(biāo)準(zhǔn)英特爾 CPU 背面,并結(jié)合 3D 打印歧管實(shí)現(xiàn)微流體冷卻。通過(guò)該技術(shù),CPU 可在超頻至 TDP 兩倍功率下安全運(yùn)行,熱阻降低 44%,所需冷卻液量?jī)H為傳統(tǒng)冷板的三十分之一。
這些發(fā)展表明,微流體冷卻正在從實(shí)驗(yàn)室研究逐步走向?qū)嶋H應(yīng)用,為高功率密度芯片和未來(lái) 3D 芯片架構(gòu)提供了可行的散熱方案。

標(biāo)簽: 芯片元器件 點(diǎn)擊: 評(píng)論:
