功率半導體器件是電力電子系統的主要組成部件。IGBT功率器件的使用壽命可以達到30年左右,因此在實際工作條件下測試IGBT功率器件的可靠性是不現實的,需要引入加速老化試驗。功率循環試驗是用于評估半導體可靠性的最常見的熱加速測試之一。由于實際應用中IGBT功率模塊的結溫波動(ΔTj)一般為40 K,在測試中,ΔTj一般需要達到70 K以上;采用不同的試驗條件,構建器件的壽命預測模型,可以推斷器件在實際工況下的壽命。20世紀90年代,瑞士研究人員發起了一個名為LESIT的項目,對大量IGBT模塊進行功率循環測試,并建立了壽命預測模型,包括兩個最重要的參數:結溫擺幅(?Tj)和介質溫度(Tm)。目前研究來看,可以認為ΔTj、Tm、ton和Ic是影響IGBT模塊功率循環壽命的四個最重要的測試條件。因此,在研究某一試驗條件對IGBT模塊的影響時,需要確保其他試驗條件保持不變。
在功率循環試驗中,ton、Ic和冷卻條件的不同組合可以在一個模塊中產生相同的ΔTj和Tm。冷卻條件包括但不限于冷卻劑的類型,溫度和流量以及TIM的類型和厚度。TIM對從結到散熱器的總熱阻Rth的貢獻超過50%。當功率損耗和ton恒定時,結溫將隨TIM的Rth而變化。但在電加熱條件(ΔTj、Tm、ton和Ic)不變的情況下,TIM對整個測試的影響未知且不能忽視,同時相同的IGBT模塊在不同的冷卻條件下是否具有相同的功率循環壽命值得研究。

合肥工業大學王佳寧研究團隊,針對標準IGBT模塊直流功率循環試驗中冷卻條件(包括但不限于冷卻劑的類型、溫度和流量以及熱界面材料(TIM)的類型和厚度)可能對整個試驗過程產生影響,采用不同種類和厚度的 TIM 來改變冷卻條件,并用冷卻時間 toff定量表征。研究了TIM對IGBT模塊功率循環壽命的影響,結果表明,當toff變長時,IGBT模塊的功率循環壽命將會提高。為了進一步研究IGBT在不同冷卻條件下的失效機制,進行了熱-力學聯合仿真。研究成果以“Impact of thermal interface material on power cycling lifetime of IGBT module”為題發表于《Microelectronics Reliability》期刊。
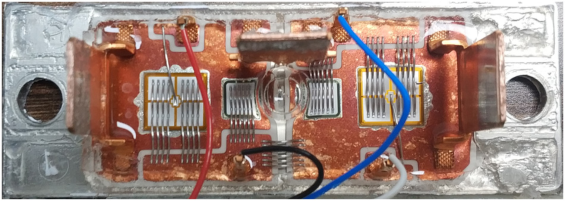
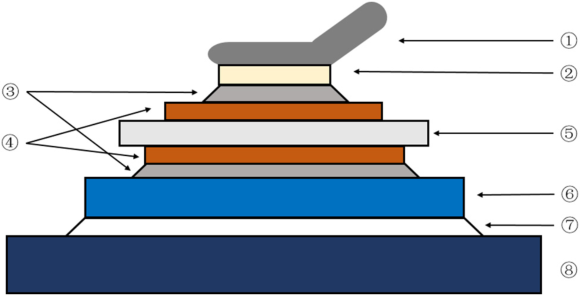
1:鍵合線,2:芯片,3:焊錫,4:銅,5:DCB,6:基板,7:TIM,8:散熱器。
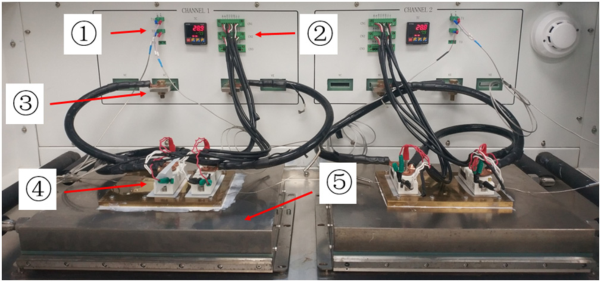
1:熱電偶,2:信號采集線,3:直流電源,4:DUT,5:散熱器。


實驗測試條件。

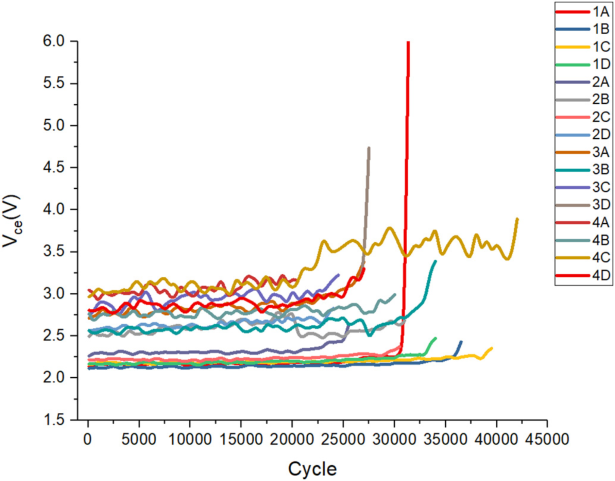

DUT 1A在功率循環測試期間的Vce和Rth(j-h)趨勢。
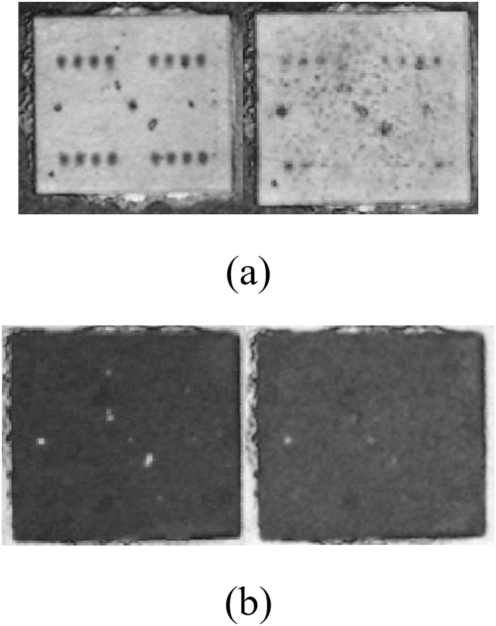
IGBT模塊測試前后的SAM圖(a):Bonding界面;(b):芯片貼裝。
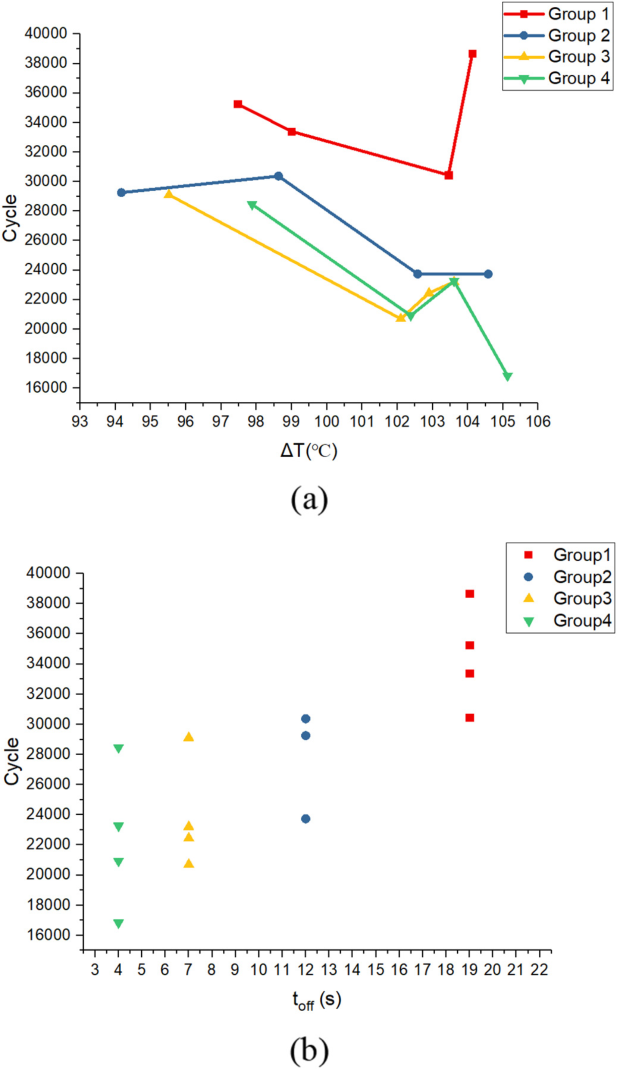
不同 TIM 下 DUTs 的失效周期。

FEM的網格模型。

模型中使用的材料參數。

模擬和實驗分組相同設置條件下,相同模擬中不同組的規格。




(a):鍵合線結構示意圖;(b):第4組鍵合線的等效應力(toff =4s);(c):第4組鍵合線的溫度分布 (toff=4s)。


本文采用功率循環試驗和熱-力學聯合仿真方法,研究了TIM熱阻對IGBT模塊功率循環壽命和失效模式的影響。試驗采用單變量控制方法。除TIM熱阻不同外,其他電加熱條件(負載電流、負載脈沖持續時間、結溫、結溫波動)完全一致。柵極電壓用于調節DUT的功率損耗。
可以得出以下結論:1)TIM熱阻的增加有助于提高功率循環壽命。主要的失效模式是引線鍵合剝離。2) 由于溫度較高,靠近芯片中心的鍵合線比靠近邊緣的鍵合線更容易損壞。因此,本次測試中 IGBT 模塊的功率循環壽命取決于中心鍵合線(4號和 5號鍵合線)的壽命。鍵合線的失效點主要是跟部區域。第一鍵的上升跟部區域最有可能破裂。3)由于TIM的功率損耗較小,熱阻較高,芯片中心區域溫度降低,芯片水平溫度梯度減小,使得中心鍵合線上的等效(von Mises)應力減小并且壽命得到改善。未來將進一步研究其他冷卻條件對IGBT模塊功率循環壽命的影響,提出一種考慮冷卻條件壽命的預測方法。
標簽:
導熱界面材料 點擊:
版權聲明:除非特別標注,否則均為本站原創文章,轉載時請以鏈接形式注明文章出處。