
摘要:雙面散熱(Double-sided cooling, DSC)封裝能大幅降低封裝寄生電感和結(jié)殼熱阻,提升電氣裝備的功率密度,是SiC 功率模塊的發(fā)展趨勢(shì)。然而,DSC SiC 功率模塊的失效機(jī)理不明、壽命模型缺失,成為制約其商業(yè)化應(yīng)用的關(guān)鍵瓶頸,亟待技術(shù)突破。傳統(tǒng)加速老化實(shí)驗(yàn)方法的成本較高、耗時(shí)較長(zhǎng),不利于產(chǎn)品的快速迭代升級(jí)。針對(duì) DSC SiC 功率模塊的可靠性研究,文中提出一種基于有限元的分析方法,基于材料的疲勞老化模型及功率模塊的失效判據(jù),建立DSC SiC 模塊的壽命模型。基于大量功率模塊的壽命測(cè)試結(jié)果,驗(yàn)證了有限元模型的可行性和有效性,相對(duì)誤差小于 6%。此外,詳細(xì)分析SiC和Si功率模塊焊層的應(yīng)力和蠕變規(guī)律,建立不同封裝功率模塊的壽命模型。結(jié)果表明:相對(duì)于單面散熱封裝,DSC 封裝功率模塊的壽命提升一倍。采用相同封裝,SiC 功率模塊的壽命是 Si 功率模塊壽命的 30%左右。此外,還詳細(xì)分析了不同封裝材料對(duì) DSC SiC 功率模塊壽命的影響規(guī)律。為下一代DSC SiC功率模塊的研發(fā)與應(yīng)用,提供有益的參考。
關(guān)鍵詞:雙面散熱;SiC 功率模塊;可靠性分析;壽命模型
0 引言
隨著晶圓材料和芯片工藝的快速發(fā)展,SiC 功率器件的成本持續(xù)降低,在國(guó)防軍工、電動(dòng)汽車(chē)、新能源等領(lǐng)域,得到廣泛應(yīng)用。低感、高溫、低熱阻、低成本的 SiC 功率模塊得到持續(xù)關(guān)注,對(duì)功率模塊的封裝結(jié)構(gòu)和封裝工藝提出了更高的要求。相對(duì)于單面散熱封裝(Single-sided cooling, SSC),雙面散熱(Double-sided cooling, DSC)封裝的 SiC 功率模塊,充分利用芯片正面的散熱通道,降低模塊35%的結(jié)殼熱阻。此外,DSC 封裝可以消除模塊的鍵合線,減小 80%的封裝寄生電感。可以提高電氣裝備的開(kāi)關(guān)頻率,降低對(duì)熱管理的需求,從而提高裝備的功率密度。近年來(lái),日本豐田、日本日立、美國(guó)德?tīng)柛!⒅袊?guó)中車(chē)等公司,已經(jīng)開(kāi)始探索 DSC SiC 功率模塊的商業(yè)化應(yīng)用。然而,DSC SiC 功率模塊的失效機(jī)理、壽命模型等基礎(chǔ)問(wèn)題,還有待進(jìn)一步的深入研究。
在 DSC SiC 功率模塊的研究方面,部分文獻(xiàn)研究了功率模塊的優(yōu)化設(shè)計(jì)、封裝結(jié)構(gòu)、封裝工藝、壽命模型。在優(yōu)化設(shè)計(jì)方面,針對(duì) DSC SiC 功率模塊多物理場(chǎng)之間的相互耦合和相互制約,以封裝結(jié)構(gòu)的尺寸為優(yōu)化變量,以結(jié)殼熱阻、應(yīng)力應(yīng)變?yōu)閮?yōu)化目標(biāo),可以實(shí)現(xiàn)熱-力協(xié)同的封裝優(yōu)化設(shè)計(jì)。
在封裝結(jié)構(gòu)方面,為了進(jìn)一步降低 DSC SiC 功率模塊的封裝寄生電感,基于磁路相消理論,可以采用P-cell/N-cell 概念,縮短功率回路,減小回路面積。此外,采用先進(jìn)的封裝結(jié)構(gòu),譬如:倒裝、3D封裝等,可以有效降低封裝寄生電感。在封裝工藝方面,為了提升 DSC SiC 功率模塊的焊層可靠性,可以采用“低溫焊接、高溫服役”的先進(jìn)焊接技術(shù),譬如:納米銀燒結(jié)、瞬態(tài)液相燒結(jié)等技術(shù),提升 DSC SiC 功率模塊的可靠性。在壽命模型方面,現(xiàn)有 SSC Si 功率模塊的壽命模型,可以為研究 DSC SiC 功率模塊的壽命模型,提供借鑒。現(xiàn)有功率模塊的壽命模型,普遍采用 Coffin-Manson 模型,表征了熱循環(huán)應(yīng)力與壽命之間的映射規(guī)律。
針對(duì)鉛焊料在熱循環(huán)試驗(yàn)中的壽命,普遍采用 Norris -Landzberg 模型。隨后,Salmela O 等利用實(shí)驗(yàn)數(shù)據(jù)對(duì)該模型進(jìn)行了修正,并將其擴(kuò)展到無(wú)鉛焊料。在焊料壽命的基礎(chǔ)上,英飛凌公司提出了 Bayerer模型,計(jì)及開(kāi)通時(shí)間、鍵合線電流、鍵合線直徑等諸多影響因素,更詳細(xì)地表征功率模塊的壽命。針對(duì)新興的無(wú)焊料 SKiM 封裝功率模塊,計(jì)及鍵合線的影響,賽米控公司提出了改進(jìn)的壽命模型。
綜上,現(xiàn)有 DSC SiC 功率模塊的研究,目前主要集中在電學(xué)、熱學(xué)、力學(xué)性能的表征與優(yōu)化,顯示出其低感、低熱阻的技術(shù)優(yōu)勢(shì)。然而,DSC SiC 功率模塊的失效模式、失效機(jī)理、應(yīng)力分布規(guī)律等基礎(chǔ)研究?jī)?nèi)容,還鮮有報(bào)道。此外,DSC SiC 功率模塊的壽命模型及其影響規(guī)律,還是一片空白。
針對(duì) DSC SiC 功率模塊可靠性不明、壽命模型缺失的問(wèn)題,本文詳細(xì)研究 DSC SiC 功率模塊的失效模式、老化規(guī)律和壽命模型。基于有限元分析方法,建立功率模塊的可靠性分析模型,并和實(shí)驗(yàn)結(jié)果進(jìn)行校核。基于焊料的疲勞老化模型,建立 DSC SiC 功率模塊的壽命模型,并分析不同封裝材料、封裝結(jié)構(gòu)對(duì)功率模塊壽命的影響規(guī)律。本文為 DSC SiC 模塊的可靠性研究,提供了新的思路,為 SiC功率模塊的設(shè)計(jì)研發(fā),提供了新的方法,為 SiC 功率變換器的壽命評(píng)估,提供了基礎(chǔ)模型。
1 SSC 和 DSC 功率模塊的結(jié)構(gòu)特點(diǎn)和失效模式
1.1 DSC功率模塊
如圖 1(a)所示,傳統(tǒng) SSC 封裝的功率模塊為典型的異質(zhì)集成結(jié)構(gòu),芯片底面焊接到直接覆銅板(Direct bonding copper, DBC)的上銅層,芯片頂面與上銅層的電氣互連依靠鍵合線完成。芯片產(chǎn)生的熱量通過(guò)多層結(jié)構(gòu)傳遞到散熱器,然后耗散到環(huán)境中。

如圖1(b)所示,DSC封裝的功率模塊由2層DBC、墊高、3 層焊料和芯片組成。相對(duì)于 SSC 功率模塊,DSC 功率模塊增加了頂面散熱通道,極大地降低功率模塊的結(jié)-殼熱阻。芯片功率損耗產(chǎn)生的熱量,同時(shí)通過(guò)頂部和底部的多層結(jié)構(gòu),進(jìn)入散熱器,最終耗散到環(huán)境中,提高散熱效率。圖 2 進(jìn)一步給出了650V 電壓等級(jí) DSC 和 SSC 功率模塊的熱阻對(duì)比。功率模塊的熱阻隨著額定電流的增加,指數(shù)下降。DSC功率模塊的熱阻比SSC功率模塊減小18%以上。

此外,DSC 功率模塊采用頂面的 DBC 代替鍵合線互連,通過(guò)優(yōu)化封裝設(shè)計(jì),可以有效降低功率模塊的寄生參數(shù)。
經(jīng)過(guò)上述對(duì)比,不難發(fā)現(xiàn) DSC 功率模塊在結(jié)構(gòu)上的特點(diǎn):沒(méi)有流過(guò)功率回路的鍵合線;增加了芯片上表面的多層結(jié)構(gòu)(即墊片、焊料、DBC);芯片有 3 層焊料。DSC 功率模塊在結(jié)構(gòu)上的差異,會(huì)給可靠性分析帶來(lái)較大的差異。
1.2 SSC和DSC 功率模塊的失效模式
功率模塊的疲勞失效直接決定于封裝結(jié)構(gòu)和封裝工藝。在功率模塊內(nèi),硅-銅-陶瓷異質(zhì)層的熱膨脹系數(shù)(Thermal expansion coefficient, CTE)和楊氏模量不匹配,在功率循環(huán)和溫度循環(huán)下,形成功率模塊內(nèi)的熱-機(jī)械應(yīng)力,在異質(zhì)層的界面處形成疲勞失效。
如圖 3 所示,SSC 功率模塊的失效模式主要表現(xiàn)為鍵合線失效、焊料層失效等。由于 DSC功率模塊不存在鍵合線,其失效模式主要為焊料層失效。然而,DSC 功率模塊的失效機(jī)理和失效模式還不明晰。尤其是,相對(duì)于 SSC 功率模塊的單層焊料,DSC 功率模塊存在三層焊料,其焊層的薄弱環(huán)節(jié)、失效的先后順序等,都有待進(jìn)一步深入研究。
DSC 功率模塊仍然采用異質(zhì)集成結(jié)構(gòu),可以視為兩個(gè) SSC 功率模塊的疊加。因此,可以借鑒 SSC功率模塊的失效機(jī)理和壽命模型,分析 DSC 功率模塊的失效機(jī)理,建立其壽命模型。

功率模塊的設(shè)計(jì)壽命通常為 10 年,為了暴露功率模塊的失效模式,可以采用功率循環(huán)等加速老化實(shí)驗(yàn)方法,測(cè)試表征功率模塊的壽命。雖然功率循環(huán)測(cè)試是商業(yè)化功率模塊的必需環(huán)節(jié),但是功率循環(huán)測(cè)試周期長(zhǎng)、代價(jià)高,不適用于功率模塊概念設(shè)計(jì)階段。如何快速評(píng)估模塊的預(yù)期壽命,掌握封裝結(jié)構(gòu)和封裝材料對(duì)模塊壽命的影響規(guī)律,亟待技術(shù)突破。
為了適應(yīng)概念設(shè)計(jì)階段的技術(shù)需求,快速、準(zhǔn)確地掌握功率模塊的預(yù)期壽命,可以采用多物理場(chǎng)設(shè)計(jì)方法,結(jié)合有限元(Finite element analysis, FEA)模型及其校正技術(shù),建立功率模塊的在線壽命評(píng)估模型。然后,采用該模型,預(yù)測(cè)和評(píng)估不同封裝結(jié)構(gòu)和封裝材料對(duì)功率模塊壽命的影響規(guī)律,快速評(píng)估封裝設(shè)計(jì)的可靠性水平,優(yōu)化封裝設(shè)計(jì)的技術(shù)路線。
2 SSC 功率模塊壽命的有限元建模及驗(yàn)證
2.1 SSC 功率模塊的有限元模型
建立功率模塊的壽命模型需要大量的數(shù)值計(jì)算,在保證精度的前提下,降低模型維度,簡(jiǎn)化模型難度,有利于提升計(jì)算效率。以焊層疲勞的失效模式為研究對(duì)象,以功率模塊的壽命評(píng)估為目標(biāo),在 COMSOL 多物理場(chǎng)仿真軟件中,建立 SSC 功率模塊的有限元模型。如圖 4 所示,多物理場(chǎng)分析理論表明,二維有限元模型在保證 95%計(jì)算精度的前提下,可以提高 10 倍以上的計(jì)算速度。因此,為了提高模型的可重復(fù)性,在保證足夠計(jì)算精度的前提下,將 SSC 功率模塊的三維物理模型,降維為二維有限元模型。

以典型的SSC Si 半橋功率模塊SKM50GB123D為例 , 采 用 50A/1200V 的 Si IGBT 芯片SIGC41T120R3E,其內(nèi)部結(jié)構(gòu)如圖 5 所示。在功率模塊內(nèi)部,芯片之間距離較遠(yuǎn),芯片之間的熱耦合效應(yīng)可以忽略不計(jì)。因此,可以抽取其中的單芯片基本封裝單元,作為研究對(duì)象,各層的結(jié)構(gòu)尺寸和材料屬性如表 1 所示。在此基礎(chǔ)上,借助幾何對(duì)稱(chēng)性,可以將 SSC 功率模塊的三維模型轉(zhuǎn)換為二維模型。

在二維有限元模型的基礎(chǔ)上,需要配置材料的本構(gòu)模型。從材料力學(xué)的角度來(lái)看,根據(jù)材料的工作溫度和熔點(diǎn),功率模塊的封裝材料主要分為線彈性材料和粘塑性材料。
半導(dǎo)體、銅和陶瓷材料的工作溫度遠(yuǎn)低于其熔點(diǎn),可以視為線彈性材料。線彈性材料的應(yīng)力應(yīng)變規(guī)律滿足胡克定律:

其中,σ 和 ε 分別為材料的應(yīng)力和應(yīng)變,E 為材料楊氏模量。
然而,焊料的工作溫度約為其熔點(diǎn)的一半,應(yīng)視為粘塑性材料。焊料內(nèi)部的蠕變和應(yīng)力松弛現(xiàn)象非常明顯,應(yīng)力和應(yīng)變均為工作溫度和持續(xù)時(shí)間的函數(shù)。粘塑性材料的塑性應(yīng)變和蠕變規(guī)律,可以采用材料的本構(gòu)方程來(lái)表征。對(duì)于常用的Anand模型,等效應(yīng)力 σ 與形變阻抗 s 成正比,即

可見(jiàn),材料的 Anand 本構(gòu)模型包含 9 個(gè)變量,對(duì)于 SAC305 焊料,其模型參數(shù)如表 2 所示。
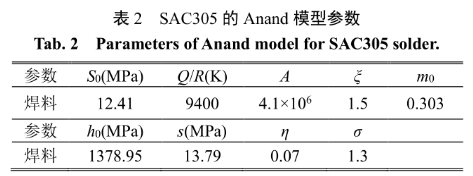
基于圖5 所示的對(duì)稱(chēng)二維模型,邊界條件設(shè)置如圖 6 所示。此外,功率芯片設(shè)置為特定體積功率密度的熱源,DBC 的底面設(shè)置為輥支撐,且散熱條件設(shè)置為強(qiáng)迫水冷。模型的左邊界設(shè)為對(duì)稱(chēng)邊界,以減小內(nèi)存;模型的其余邊界均設(shè)置為絕熱,且自由移動(dòng)。

在有限元分析模型中,采用物理壽命模型,評(píng)估功率模塊的壽命。在功率芯片上施加方波的功率密度,模擬功率模塊的功率循環(huán)實(shí)驗(yàn)。改變方波的幅值和換熱邊界的環(huán)境溫度,可以得到功率模塊在不同結(jié)溫循環(huán)下的溫度、應(yīng)力、應(yīng)變規(guī)律。結(jié)合Anand模型,可以得到焊料的塑性應(yīng)變和蠕變。為了獲得焊料層應(yīng)變和壽命之間的映射,可以采用 Morrow 模型

其中,N sf 為焊料層失效前的功率循環(huán)周次,ΔWsc 為一次功率循環(huán)所累計(jì)的蠕變能量,Wsf 和ms分別為材料的疲勞能量系數(shù)和疲勞能量指數(shù)。對(duì)于 SAC305 焊料合金,模型的取值為Wsf = 55×10 6 J/m3 、ms = –0.69。
在實(shí)際中,基于應(yīng)變的 Morrow 模型難于量測(cè)。因此,通常所說(shuō)的壽命模型是指和結(jié)溫波動(dòng)相關(guān)的壽命特性。焊層的疲勞老化,引起熱阻的增加,進(jìn)而導(dǎo)致功率模塊失效。根據(jù)焊層失效模型,基于Coffin-Manson 模型,可以得到功率模塊的壽命模型

其中,Nf 為功率模塊的壽命,為功率循環(huán)結(jié)溫,c1和 c2 分別為功率循環(huán)壽命系數(shù)。此外,考慮功率循環(huán)過(guò)程中平均結(jié)溫的影響,可以采用 Coffin-Manson-Arrhenius 模型來(lái)描述功率模塊的壽命,即

其中,a和n為與初始?jí)勖徒Y(jié)溫波動(dòng)相關(guān)的常數(shù),Ea 為激活能,k = 8.62×10 –5 eV/K 為玻爾茲曼常數(shù),Tjm 為平均結(jié)溫。
2.2 功率循環(huán)實(shí)驗(yàn)及有限元模型的驗(yàn)證
典型功率循環(huán)實(shí)驗(yàn)的電路原理如圖 7 所示,控制開(kāi)關(guān)采用功率模塊 SKM75GB123D,為了提高測(cè)試速度和增強(qiáng)對(duì)比參照,將 22 個(gè)被測(cè)功率模塊串聯(lián)測(cè)試 [31] 。功率模塊的失效判據(jù)定為 20%的結(jié)殼熱阻增加。在有限元模型中采用了芯片和封裝一致性,因而可以利用該數(shù)據(jù)進(jìn)行實(shí)驗(yàn)驗(yàn)證。

當(dāng)平均結(jié)溫Tjm 為90℃時(shí),設(shè)置ΔTj 分別為90℃和 120℃,測(cè)試功率模塊的功率循環(huán)壽命,實(shí)驗(yàn)結(jié)果如圖 8 所示。可以發(fā)現(xiàn),實(shí)驗(yàn)結(jié)果與式(9)所示的理論模型吻合較好,辨識(shí)得到的功率模塊壽命模型參數(shù)為 c1= 5.2×10(12)、c2= 4.2。此外,不同溫度下的有限元仿真結(jié)果也與理論的壽命模型相差不大,相對(duì)誤差小于 6%。

3 DSC 功率模塊的應(yīng)力和壽命分布規(guī)律
3.1 DSC 功率模塊的有限元模型
基于 SSC 功率模塊的有限元模型,采用實(shí)驗(yàn)結(jié)果校驗(yàn)了該模型對(duì) SSC 功率模塊壽命預(yù)測(cè)的可行性。這里進(jìn)一步探索 DSC 功率模塊的有限元模型,以分析 DSC 功率模塊的壽命模型及其影響規(guī)律。
在 DSC 功率模塊的有限元模型中,采用相同尺寸的 IGBT 芯片,進(jìn)行對(duì)比分析,如圖9 所示。芯片底面的封裝材料和封裝尺寸與 SSC 功率模塊完全相同。芯片頂面采用與底面相同的DBC,并在芯片和DBC之間引入了鉬片墊高層,其結(jié)構(gòu)尺寸為 6.0mm×5.7mm×2.5mm,其材料的熱膨脹系數(shù)為4.8×10–6 /K、楊氏模量為329GPa 、熱導(dǎo)率為139W/(m·K)。鉬片與芯片的連接,仍采用 0.12mm厚的 SAC305 焊料。

3.2 DSC 功率模塊的失效判據(jù)
為了評(píng)估功率模塊的壽命,需要確定模塊的失效判據(jù)。對(duì)于 SSC 功率模塊的失效判據(jù),相對(duì)比較成熟。然而,DSC 功率模塊的失效判據(jù)還處于探索階段。這里,基于 SSC 功率模塊的失效判據(jù),探索DSC 功率模塊的失效判據(jù)。
在功率循環(huán)中,非彈性應(yīng)變能容易在邊角聚集,因而,焊料層邊角處首先開(kāi)裂失效,導(dǎo)致熱阻增加,最終導(dǎo)致功率模塊失效。對(duì)于 SSC 功率模塊,其失效判斷標(biāo)準(zhǔn)通常選為熱阻增加 20%。但是,該失效判據(jù)并未指明所對(duì)應(yīng)的焊層失效比例。對(duì)于 DSC 功率模塊,其存在三層焊料,各層焊料失效的先后順序,以及對(duì)模塊結(jié)殼熱阻的影響,都還有待深入研究。
基于圖 9 所示有限元模型,在結(jié)溫波動(dòng)為 ΔTj =120℃的功率循環(huán)測(cè)試條件下,圖 10 給出了 DSC Si功率模塊的多物理場(chǎng)分析結(jié)果。可以發(fā)現(xiàn),鉬片上層焊料、芯片頂層焊料失效約 5%之后,便不再明顯退化,DSC 功率模塊的焊層失效仍然以芯片底層焊料的失效為主。由于場(chǎng)限環(huán)的限制,芯片頂面的有效散熱通道減小,且焊料層數(shù)更多,并含有墊高層,都會(huì)增加頂面封裝結(jié)構(gòu)的厚度和熱阻。因此,芯片的損耗主要通過(guò)底面耗散到環(huán)境中,芯片底面的熱通量更大,且溫度梯度更高,壽命更短,是DSC 功率模塊的薄弱環(huán)節(jié).

基于圖 9 所示有限元模型,圖 11 進(jìn)一步給出了各層焊料失效比例對(duì) DSC 功率模塊結(jié)殼熱阻的影響規(guī)律。可以發(fā)現(xiàn),對(duì)于 SSC 功率模塊,當(dāng)焊料層失效 9%左右,模塊的結(jié)殼熱阻增加 20%,即達(dá)到SSC功率模塊的失效判據(jù)。對(duì)于DSC功率模塊,各層焊料失效比例對(duì)結(jié)殼熱阻的影響規(guī)律,與 SSC功率模塊基本一致。因此,可以沿用結(jié)殼熱阻增加20%作為 DSC 功率模塊的失效判據(jù)。此外,結(jié)殼熱阻對(duì)芯片底面焊料的失效最為敏感,當(dāng)?shù)讓雍噶鲜?8%時(shí),可以判定 DSC 功率模塊失效。

3.3 DSC 功率模塊的應(yīng)力分布規(guī)律
功率模塊的應(yīng)力計(jì)算本質(zhì)是對(duì)多層結(jié)構(gòu)的應(yīng)力分析,忽略了連接層厚度,進(jìn)行一定的簡(jiǎn)化,求解微分方程組,得到異質(zhì)層交界面的應(yīng)力分布規(guī)律

其中,τ 為連接面的剪應(yīng)力,常數(shù) k 和 λ 為與材料的楊氏模量、厚度等相關(guān)的系數(shù),α 為材料的熱膨脹系數(shù),x 為到對(duì)稱(chēng)中心的距離。由式(11)可知,越靠近芯片邊緣,應(yīng)力越大;材料的熱膨脹系數(shù)相差越多,應(yīng)力越大。相對(duì)于有限元方法,數(shù)學(xué)解析模型能得到一定的規(guī)律,并做出一定的物理解釋?zhuān)悄P图僭O(shè)過(guò)于理想,準(zhǔn)確性較差。此外,為了分析功率模塊的蠕變耗散能,評(píng)估功率模塊的壽命,有限元分析方法更為方便。因此,本文采用有限元模型來(lái)分析功率模塊的熱-力行為。
焊料層邊角處是裂紋萌芽地帶,此處的應(yīng)力和非彈性應(yīng)變也較為集中。因此,分析焊料層邊角處的應(yīng)力應(yīng)變聚集情況,能夠較好地揭示焊料層的失效機(jī)理。針對(duì) SSC Si 和 DSC Si 功率模塊,圖 12對(duì)比了焊料層的蠕變耗散能分布情況。可以發(fā)現(xiàn):對(duì)于 DSC Si 功率模塊,焊料層邊角處的應(yīng)變聚集區(qū)域更小,有利于減緩裂紋的萌發(fā),提升其功率循環(huán)壽命。

在功率循環(huán)過(guò)程中,SSC 和 DSC 功率模塊受到的應(yīng)力應(yīng)變和蠕變行為有著明顯的差異。以循環(huán)溫度ΔTj = 120℃時(shí)為例,焊料層的應(yīng)力和蠕變特性,如圖 13。相對(duì)于 SSC 功率模塊,DSC 功率模塊的芯片頂面結(jié)構(gòu)兼具耗散功率和平衡應(yīng)力的作用,減小芯片焊料層的 5%應(yīng)力、15%蠕變應(yīng)變率和 20%蠕變能密度。根據(jù)式(8),單次功率循環(huán)所積累的蠕變能量決定是焊料層的疲勞壽命,進(jìn)而影響功率模塊的功率循環(huán)壽命。可見(jiàn),相對(duì)于 SSC 功率模塊,DSC 功率模塊能夠明顯降低焊料層的應(yīng)力應(yīng)變,顯著提升其功率循環(huán)壽命。
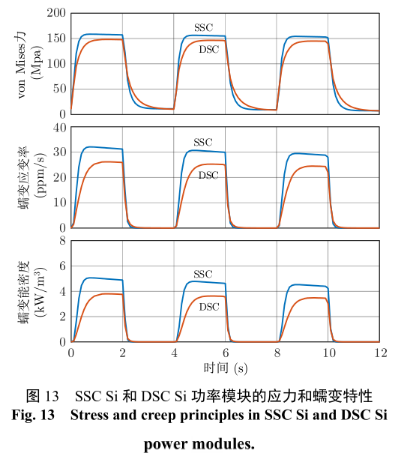
最終,通過(guò)有限元分析得到的循環(huán)壽命分布如圖 14,與圖 12 和圖 13 所示的應(yīng)力分析結(jié)果基本一致。模塊從焊料層邊角處開(kāi)始失效,其中 DSC 模塊的失效以芯片底部的焊料層失效為主。頂部?jī)蓪雍噶显谶吔鞘Ш螅驗(yàn)殂f墊片的原因,向內(nèi)發(fā)展得很慢。因此,雙面散熱模塊對(duì)器件壽命的提升具有顯著的效果。

4 DSC SiC 功率模塊的壽命模型及影響規(guī)律
4.1 DSC SiC 功率模塊的應(yīng)力行為分析
前述分析表明,采用 DSC 封裝,可以降低 Si功率模塊的熱應(yīng)力,提升 Si 功率模塊的壽命。這里進(jìn)一步深入分析 DSC 對(duì) SiC 功率模塊的壽命影響規(guī)律。
如表 1 所示,由于材料的性能差異,相對(duì)于 Si芯片,SiC 芯片的楊氏模量更大、面積更小,在 DSC功率模塊的模型中,鉬片的大小調(diào)整為3mm×2.9mm,其余參數(shù)不變。
SSC SiC 功率模塊的應(yīng)力應(yīng)變更加集中,約是SSC Si 功率模塊的 1.5 倍。但是,采用 DSC 封裝結(jié)構(gòu),能夠減小 SiC 功率模塊的應(yīng)力,大幅提升其壽命。SSC SiC 和 DSC SiC 功率模塊的應(yīng)力和蠕變特性,如圖 15。類(lèi)似于 Si 功率模塊,相對(duì)于 SSC封裝,DSC 封裝能顯著降低 von Mises 力、蠕變應(yīng)變率和蠕變能密度,提升 SiC 功率模塊的壽命。對(duì)比圖 13 和圖 15 可以發(fā)現(xiàn):對(duì)于相同的封裝技術(shù),SiC 功率模塊的應(yīng)力應(yīng)變?nèi)匀淮笥?Si 功率模塊。因此,相同封裝條件下,SiC 功率模塊的焊料層壽命少于 Si 功率模塊,如圖 16 所示。與 Si 功率模塊類(lèi)似,相對(duì)于 SSC 封裝,DSC 封裝能顯著提升 SiC功率模塊的壽命。

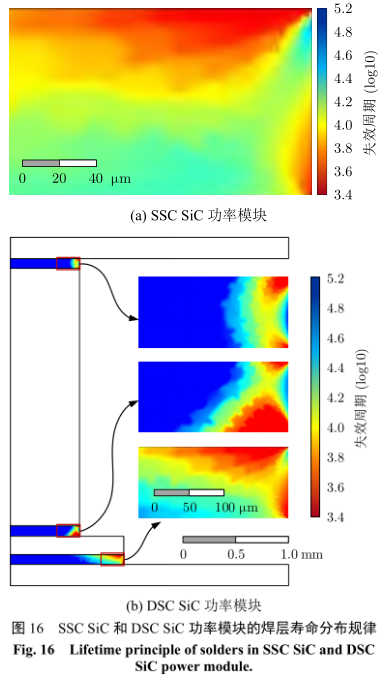
4.2 DSC SiC 功率模塊的壽命模型
基于前述有限元模型和分析方法,針對(duì) Tjm = 90℃時(shí)的有限元分析結(jié)果。不同 ΔTj 時(shí),DSC SiC 功率模塊的功率循環(huán)壽命,如圖17所示。采用式(9)所示的Coffin-Manson 模型,可以得到DSC SiC功率模塊的壽命模型。模型參數(shù)的擬合結(jié)果為:c1=2.65×10(9) 、c2 = 2.43。

進(jìn)一步考慮 Tjm 的影響,基于式(10)所示的Coffin-Manson-Arrhenius 模型,圖 18 給出了 DSCSiC 功率模塊的壽命分布規(guī)律。當(dāng) ΔTj 相同時(shí),Tjm越大,功率模塊的壽命越短;當(dāng) Tjm 相同時(shí),ΔTj越大,功率模塊的壽命也越短。此外,有限元分析的結(jié)果與式(10)所示模型的預(yù)測(cè)結(jié)果基本一致。辨識(shí)得到的模型參數(shù)為:a =56.39,n =2.57,Ea =0.57eV。

對(duì)于 Si 和 SiC 器件,采用 SSC 和 DSC 封裝,當(dāng) Tjm = 90℃時(shí),功率模塊的壽命分布規(guī)律如圖 19所示。不難發(fā)現(xiàn),SSC SiC 功率模塊的壽命約為 SSCSi 功率模塊壽命的 30%。隨著 ΔTj 增加,二者壽命的差異減小。此外,DSC SiC 功率模塊的壽命是約為 SSC SiC 功率模塊壽命的 2 倍。值得指出的是,相對(duì)于 SSC Si 功率模塊,當(dāng) ΔTj 較低時(shí),DSC SiC功率模塊的壽命提升效果并不明顯。但是,當(dāng) ΔTj較高時(shí),DSC SiC 功率模塊的壽命遠(yuǎn)大于 SSC Si功率模塊的壽命。從壽命指標(biāo)的角度來(lái)看,DSC Si功率模塊具有最佳的性能。但是,考慮到高溫、高頻、低損的優(yōu)異性能,DSC SiC 功率模塊在高功率密度車(chē)用電機(jī)控制器的應(yīng)用,具有廣泛的應(yīng)用前景。可以預(yù)見(jiàn),在更大的 ΔTj 情況下,DSC SiC 功率模塊的優(yōu)勢(shì)會(huì)更加明顯。

4.3 封裝材料對(duì)DSC SiC 功率模塊壽命的影響
建立功率模塊的壽命模型,可以為功率模塊的概念定型和優(yōu)化設(shè)計(jì),提供基礎(chǔ)理論指導(dǎo)和關(guān)鍵技術(shù)支撐。
先進(jìn)的封裝材料有利于降低封裝熱阻,緩解焊層應(yīng)力,提高功率模塊的壽命。計(jì)及 DBC 陶瓷材料和墊高材料的影響,本節(jié)深入分析封裝材料對(duì)DSC SiC 功率模塊壽命的影響規(guī)律,材料的基本屬性如表 3 所示。

基于前述有限元模型和分析方法,不同 DBC陶瓷層材料對(duì) DSC SiC 功率模塊壽命的影響,如圖20 所示。
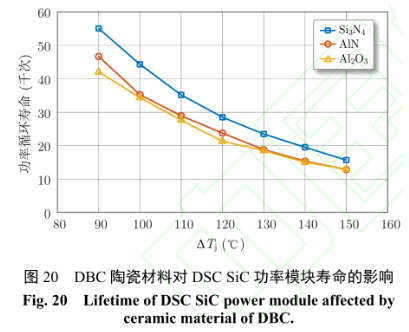
相同ΔTj 條件下,Si3N4功率模塊的可靠性最高,AlN 次之,Al2O3 最差。如表 3 所示,AlN 的熱膨脹系數(shù)大于 Si3N4 ,它與 SiC 芯片的熱失配更嚴(yán)重。然而,AlN 具有較高的熱導(dǎo)率,有助于降低結(jié)-殼熱阻。此外,AlN 的成本比 Si3N4 更低,應(yīng)用更為廣泛。由于 AlN 的熱導(dǎo)率遠(yuǎn)大于 Si3N4和 Al2O3,在相同功率條件下,功率模塊的波動(dòng)更小,有利于提升功率模塊的壽命,如圖 21。也就是說(shuō)在相同工作條件下,AlN 的熱阻更小,結(jié)溫波動(dòng)更小,工作壽命將會(huì)是更加可觀。

相對(duì)于 SSC 封裝,DSC 封裝的墊片覆蓋芯片上表面,直接影響功率模塊的壽命。選用合適的墊片材料,可以緩沖應(yīng)力,增加 DSC 功率模塊的壽命。若墊片材料選為銅,DSC SiC 功率模塊內(nèi)的焊料層壽命分布,如圖 22 所示。對(duì)比圖 16 所示鉬墊片的結(jié)果,可以發(fā)現(xiàn):采用銅墊片后,DSC SiC 功率模塊的焊料急劇失效,且墊片兩側(cè)焊料失效最快。雖然,相對(duì)于鉬墊片,雖然銅墊片能夠減小結(jié)-殼熱阻,但是其熱膨脹系數(shù)與 SiC 材料相差更大,熱應(yīng)力的失配效應(yīng)更明顯,導(dǎo)致焊層壽命顯著降低。此外,銅墊片的熱阻更小,芯片頂面的熱通量更大,溫度梯度更高,焊料層的溫差更大,進(jìn)一步加劇焊層失效。
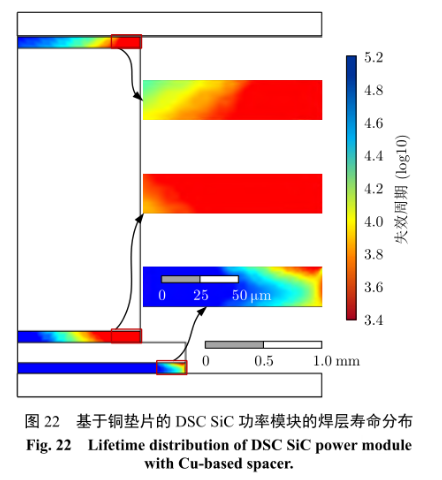
在不同ΔTj 的功率循環(huán)條件下,不同封裝的SiC功率模塊的功率循環(huán)壽命,如圖 23 所示。隨著 ΔTj的增加,DSC SiC 功率模塊的減小,采用銅墊片后,功率模塊壽命約為鉬墊片的 1/4,其壽命甚至低于SSC SiC 功率模塊。墊片材料的熱膨脹系數(shù),應(yīng)該接近于 SiC 材料,才能降低模塊的應(yīng)力,提升模塊的壽命。雖然,銅墊片能夠一定程度上減小 DSC SiC的結(jié)殼熱阻,但是其對(duì)功率模塊的壽命損耗,遠(yuǎn)不如結(jié)溫降低帶來(lái)的壽命提升。因此,對(duì)于 DSC SiC功率模塊,相對(duì)于銅墊片,雖然金屬鉬的熱導(dǎo)率稍低,但是鉬墊片仍然是更優(yōu)的選擇。

5 結(jié)論
DSC SiC 功率模塊的是未來(lái)功率模塊的重要發(fā)展方向,然而現(xiàn)在對(duì)它的可靠性分析和壽命模型欠缺。本文通過(guò)對(duì)功率模塊的簡(jiǎn)化降維,得到了一個(gè)能快速計(jì)算 DSC SiC 循環(huán)壽命的 2D 有限元模型,并且利用現(xiàn)有的數(shù)據(jù)進(jìn)行間接驗(yàn)證。針對(duì)現(xiàn)階段DSC SiC 功率模塊可靠性測(cè)試數(shù)據(jù)缺乏的問(wèn)題,本文提出了利用現(xiàn)有的 Si 器件數(shù)據(jù)進(jìn)行驗(yàn)證,為快速獲取 DSC SiC 功率模塊的壽命模型提供了一種新的思路。
本文通過(guò)現(xiàn)有的單面散熱功率模塊測(cè)試數(shù)據(jù),驗(yàn)證了有限元模型的準(zhǔn)確性,并同雙面散熱模塊對(duì)比,由此建立了針對(duì)雙面散熱模塊的壽命模型。最后,探究了襯板陶瓷材料、墊片材料對(duì)模塊壽命的影響,并給出了模塊優(yōu)化的建議。得到的結(jié)論如下:
1)對(duì)于 DSC 封裝功率模塊,若采用鉬作為墊高材料,芯片底部焊料層最先失效,且在失效過(guò)程中占主導(dǎo)地位。若采用銅作為墊高材料,以墊高層兩側(cè)焊料最先失效。
2)雙面散熱模塊的墊片建議采用鉬片,能有效地提升模塊的循環(huán)壽命。而采用銅墊片的 DSC 模塊僅為鉬的 1/4。
3)DBC 陶瓷材料建議采用 AlN 或 Si3N4,以有效降低功率模塊的熱阻,提升功率模塊的壽命。
4)采用相同封裝材料,DSC 封裝功率模塊的壽命是 SSC 封裝功率模塊的 2 倍,這種優(yōu)勢(shì)在結(jié)溫波動(dòng)較大的情況更為明顯。
本文來(lái)源:知網(wǎng),原文鏈接:https://kns.cnki.net/kcms/detail/11.2107.tm.20201230.0816.002.html
標(biāo)簽: 點(diǎn)擊: 評(píng)論:
