一般建模條件下,詳細(xì)熱封裝模型的暫態(tài)性能
摘要
使封裝芯片的熱傳導(dǎo)模型包含所有的幾何信息是不能實(shí)際運(yùn)用在產(chǎn)品生產(chǎn)流程中的。設(shè)計(jì)詳細(xì)的熱模型需用大量的對(duì)穩(wěn)態(tài)分析有效的幾何學(xué)簡(jiǎn)化。本文是要驗(yàn)證暫態(tài)情況下這些簡(jiǎn)化條件的性能,他們?cè)谶@一范圍內(nèi)應(yīng)該可以被忽略。驗(yàn)證顯示在這些假設(shè)條件下建模可以得到正確的暫態(tài)模型。
我們?cè)诓煌薅l件下的軟件工具中通過對(duì)比用與不用這些假設(shè)條件建模的方法,來對(duì)它們?cè)趯?shí)際封裝模型中的影響進(jìn)行檢測(cè),結(jié)果仍然表明使用這些假設(shè)前提可以得到正確的暫態(tài)模型。這些結(jié)果對(duì)于承擔(dān)板級(jí)和系統(tǒng)級(jí)暫態(tài)分析任務(wù)的系統(tǒng)設(shè)計(jì)師以及創(chuàng)建暫態(tài)熱壓縮模型的設(shè)計(jì)師們都是非常重要的。
簡(jiǎn)介
建立包含所有傳導(dǎo)信息和BGA封裝基片所有單個(gè)跡線的熱傳導(dǎo)封裝模型的想法無論是否可行,對(duì)于板級(jí)和系統(tǒng)級(jí)的設(shè)計(jì)來說,它是不實(shí)際的,而且無法用于模型設(shè)計(jì)的計(jì)算中。具體的熱模型設(shè)計(jì)中,一般都包括了大量的簡(jiǎn)化,這些簡(jiǎn)化可大大的減少模型的幾何復(fù)雜度,同時(shí)不會(huì)影響設(shè)計(jì)結(jié)果的質(zhì)量。這些假設(shè)多年來被廣泛應(yīng)用于穩(wěn)態(tài)分析中。
本文主要通過FLOTHERM工具用有限體積(FV)計(jì)算流體力學(xué)(CFD)的方法對(duì)這些簡(jiǎn)化條件在暫態(tài)情況下的性能作基本驗(yàn)證。也通過ANSYS和MARC兩種不同的有限元(FE)計(jì)算流體力學(xué)(CFD)工具,對(duì)兩組詳細(xì)的封裝模型進(jìn)行了檢測(cè),對(duì)比它們?cè)谟门c不用假設(shè)條件建模后的性能。
基本驗(yàn)證
1. 壓扁的晶片粘附層表述方式
1.1 具體模型
將晶片的粘附層用二維和三維兩種方式描述,對(duì)比它們產(chǎn)生的不同效果,在二維表示中,晶片粘附層被視為一扁平面,它的熱效應(yīng)是可以忽略的。具體的幾何示圖如下,以三維方式描繪粘附層:
Fig. 1: Extent of Model Showing Uncollapsed Die Attach Die Heat Sink Die Attach
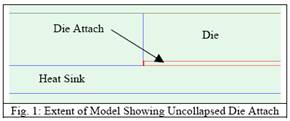
這一模型是由一個(gè)尺寸為40mm*40mm*1.5mm的銅制散熱片和一個(gè)置于其上的尺寸為10mm*10mm*0.25mm的晶體硅組成。晶片環(huán)氧粘附層厚度為0.02mm。在壓扁的情況下,晶片的厚度包括了粘附層的厚度,即增加了0.02mm。在實(shí)際的封裝模型中,這樣處理可以保持模型內(nèi)部晶片的上表面的位置不變,從而使模型內(nèi)晶片上方的材料的厚度也保持不變,因而對(duì)組件的熱阻尼的影響就會(huì)很小。一般來說,所有的材料都有熱方面的性能。
用功率為2W的平面熱源均勻地作用在晶體硅的上表面,將熱傳導(dǎo)系數(shù)分別為1*10⑶W/m⑵K;1*10⑷W/m⑵K和1*10⑸W/m⑵K的材料用于銅制底座的下表面,以表示封裝模型底部的散熱情況。周圍溫度為零攝氏度。根據(jù)對(duì)稱性,可用模型的1/4來進(jìn)行檢測(cè)。研究穩(wěn)態(tài)坐標(biāo)系的改進(jìn)方案來建立分立的網(wǎng)格結(jié)構(gòu),選擇一組47*47*40的網(wǎng)格作暫態(tài)分析。下圖中,橫坐標(biāo)上的點(diǎn)表示時(shí)間。時(shí)間步進(jìn)集中設(shè)置在有錯(cuò)誤的地方
1.2 檢測(cè)結(jié)果
下面的兩張圖表分別是中心熱源對(duì)最大和最小導(dǎo)熱系數(shù)的瞬時(shí)反映曲線。對(duì)比壓扁的和非壓扁的晶片粘附層。藍(lán)色曲線表示非壓扁;紅色曲線表示壓扁。
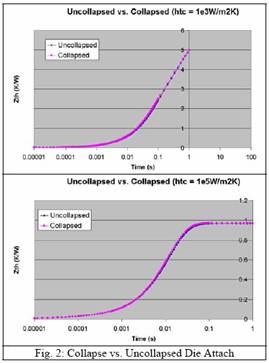
1.3 結(jié)果分析
上面的結(jié)果顯示兩種模型(壓扁粘附層和非壓扁粘附層)的熱效應(yīng)幾乎相同,只是壓扁粘附層的模型由于晶片的熱阻尼較高而顯示略高的溫度。在晶片厚度遠(yuǎn)大于粘附層厚度的情況下,這種近似是可以的。
2 平衡引線架描述
2.1 具體模型
為了檢驗(yàn)引線架區(qū)域采用集成近似所帶來的影響,我們將一個(gè)詳細(xì)的包有塑料外殼的引線架結(jié)構(gòu)的三維描述與一個(gè)熱平衡層的三維描述進(jìn)行比較。根據(jù)平面對(duì)稱性,對(duì)半個(gè)引線架構(gòu)以及與之相連的半個(gè)塑料外殼進(jìn)行單位逼近,再依據(jù)引線架外殼的上下對(duì)稱性,取上半部分建模。具體的幾何學(xué)及對(duì)稱條件的應(yīng)用如下圖所示:

如圖3a,在導(dǎo)線架模型兩端有兩個(gè)導(dǎo)熱性很強(qiáng)的立方體,我們?cè)谝欢耸┘訜嵩矗诹硪欢耸┮怨潭ǖ臒醾鲗?dǎo)系數(shù)。除去這些,模型總長(zhǎng)10mm。模型寬高分別為0.2mm和1mm。引線架覆蓋系數(shù),α,為0.5。材料性能計(jì)算公式如下:
![]()
![]()

引線周圍散熱片的熱傳遞系數(shù)分別為1*10⑷W/m⑵K;1*10⑸W/m⑵K和1*10⑹W/m⑵K。外殼上部的熱傳遞系數(shù)為20 W/m⑵K,施加0.025W的熱源,進(jìn)入暫態(tài)。周圍環(huán)境溫度為0攝氏度。進(jìn)行坐標(biāo)系改進(jìn)分析。用完全相同的坐標(biāo)系研究詳細(xì)模型和簡(jiǎn)化模型。繪制好的坐標(biāo)系的長(zhǎng)寬高分別為128*10*22。下圖顯示的坐標(biāo)系的時(shí)間步進(jìn)被完全覆蓋到了。
2.2 檢測(cè)結(jié)果
下圖分別顯示了在最大和最小熱傳遞系數(shù)下,熱源的瞬時(shí)響應(yīng)。
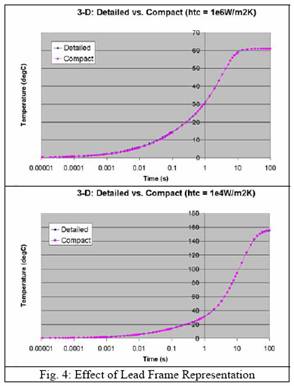
2.3 結(jié)果分析
結(jié)果顯示兩種模型的熱效應(yīng)幾乎完全相同。這種近似也是可以的。
封裝模型研究
對(duì)兩組封裝模型的研究。一種是352-BGA,另一種是80-PQFP。兩組封裝模型都是PROFIT型,即溫度變化對(duì)電子產(chǎn)品性能的影響的預(yù)測(cè)。將兩組模型置于雙面冷卻臺(tái)(DCP)上,并用墊片隔開。或許讀者對(duì)DCP方法并不熟悉,它可使熱量從封裝模型表面以不同路徑向外傳遞。如下表所示:
表1:DCP熱流路徑框圖
|
|
優(yōu)選熱流路徑 |
|
DCP-1 |
封裝模型上下表面 |
|
DCP-2 |
封裝模型下表面 |
|
DCP-3 |
封裝模型上表面 |
|
DCP-4 |
封裝模型內(nèi)部連接處(引線/焊球) |
3 HBGA352 的DCP-1 型
3.1 具體模型
一個(gè)裸露的銅制熱嵌片,通過強(qiáng)熱導(dǎo)線連于晶片PBGA的下部,模型的幾何構(gòu)型如圖5.a。這一封裝模型的組成是:一個(gè)尺寸為15.12mm* 15.12mm * 0.38mm的晶體硅通過厚85µm的膠層粘連在一個(gè)35mm* 35mm * 0.381mm的銅固定板上。晶片邊沿處的粘膠是用來粘貼BGA材料和基片的。晶片與部分BGA基片通過環(huán)氧樹脂高度粘連。封裝模型末端是靠4排間距為1.27mm的Sn63/Pb37型焊球與其它部位連接。
使用上一節(jié)給出的公式計(jì)算出施用在BGA基片的PCB內(nèi)外部的物質(zhì)屬性,在這兩部分中,銅所占的比例分別為0.19和0.1。硅的熱傳導(dǎo)性能依溫度的不同而變化。未封閉表面的對(duì)流和輻射作用在建模中忽略不計(jì)。
由于使用大功率,冷卻臺(tái)的溫度由初態(tài)的25攝氏度瞬間上升。但是,由于我們?cè)趯?shí)驗(yàn)中不對(duì)冷卻臺(tái)的熱效應(yīng)進(jìn)行測(cè)量,因此建模過程將不會(huì)包括這一信息。
進(jìn)行詳細(xì)的坐標(biāo)系改進(jìn)方案的研究。對(duì)詳細(xì)模型和簡(jiǎn)化模型使用完全相同的坐標(biāo)系。最終建立的坐標(biāo)系是62*62的模型平面坐標(biāo)和包含40個(gè)單位元素穿過基架和整個(gè)模型的縱向坐標(biāo),這些縱向元素主要集中在模型內(nèi)部。時(shí)間坐標(biāo)仍由圖表下部的點(diǎn)來表示,所有的時(shí)間步進(jìn)都集中設(shè)置在存在機(jī)械錯(cuò)誤的位置上。
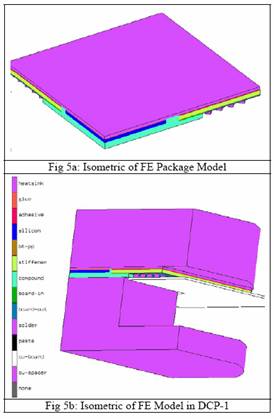
3.2 檢測(cè)結(jié)果
以5000W/m⑵K的熱傳遞系數(shù)來表示基架與冷卻臺(tái)接觸面的傳熱性能。封裝模型的總功率為55.85W。上層冷卻臺(tái)溫度為29攝氏度,下層冷卻臺(tái)溫度為26.3攝氏度,這是實(shí)驗(yàn)結(jié)束后的測(cè)量值。這些邊界條件與Philips所用的邊界條件完全相同。
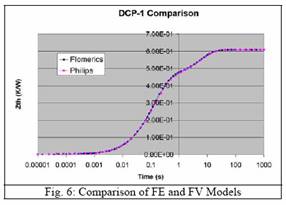
我們將結(jié)果用名詞熱阻尼,Zth,來表示,它定義如下:
![]()
在這一公式中,TJ表示晶片中心熱源的溫度,TCP表示冷卻臺(tái)的溫度,P是模型總功率。
3.3 結(jié)果分析
兩種應(yīng)用軟件的顯示結(jié)果非常一致,這正是我們期望的,因?yàn)樵趯⑺形矬w構(gòu)建為傳導(dǎo)立方體時(shí),這兩種工具的幾何模型非常相似。在FE工具中,焊球是在45攝氏度時(shí)加在模型的軸上。
從實(shí)驗(yàn)結(jié)果來看,0.5秒附近是一個(gè)重要的起始點(diǎn),從這點(diǎn)起邊界條件開始影響實(shí)驗(yàn)結(jié)果。由于模型中物質(zhì)屬性方面的數(shù)據(jù)不準(zhǔn)確,0.01秒之后實(shí)驗(yàn)結(jié)果就與數(shù)值計(jì)算的結(jié)果產(chǎn)生了偏差。
4 P-MQFP-80-1 模型在DCP-1至DCP-4的情況
4.1 具體模型
幾何模型如下圖7a所示
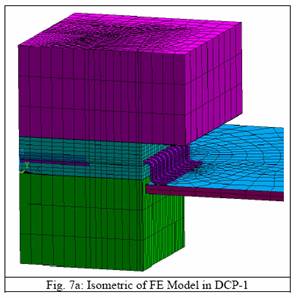
由于模型空間有限,不能包括分析時(shí)用到的所有幾何信息和物質(zhì)屬性信息。然而主要部分都有了:一個(gè)14mmx 14mm x 2.25mm的封裝體,內(nèi)有一個(gè)7.56mmx 7.56mm x 0.38mm的晶體硅,晶體硅上面是一個(gè)8mmx 8mm x 0.15mm的銅合金沖模墊,涂有一層厚20µm的模片粘附劑。模片粘附層很“薄”,對(duì)熱性能影響不大,可視為一個(gè)平面盤,因此計(jì)算時(shí)不會(huì)考慮它的熱因素。引線架的金屬覆蓋率為66%。封裝模型每個(gè)面上的引線都焊在一個(gè)厚0.5mm長(zhǎng)寬為25mmx 10mm的銅帶上。引線架部分和外部引線采用經(jīng)過平衡后的材料屬性。硅的熱傳導(dǎo)性依溫度而變化。在FE模型中,硅的熱容量也依溫度改變。這一特性在FV軟件中是不適用的。因?yàn)镮nfineon發(fā)現(xiàn)外表面的對(duì)流和輻射作用對(duì)實(shí)驗(yàn)結(jié)果的影響極小,所以它們?cè)诮V锌杀缓雎浴?/p>
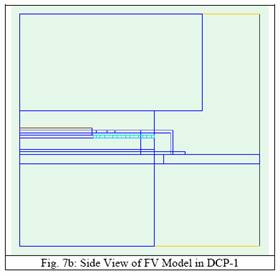
模片粘附層是壓扁的,它的厚度使模片的厚度由0.38加厚為0.382。用DCP-2和DCP-3進(jìn)行分析,非壓扁的模片粘附層會(huì)相對(duì)地通過模型頂部和底部吸取熱量。
執(zhí)行穩(wěn)態(tài)坐標(biāo)改進(jìn)方案,為檢測(cè)結(jié)果建立獨(dú)立的網(wǎng)格,用于暫態(tài)分析的網(wǎng)格在模型平面方向含111 x 117個(gè)單元,在由基架縱穿模型的方向上有51個(gè)單元,坐標(biāo)單元全都集中在模型內(nèi)部。我們?cè)俅螌r(shí)間點(diǎn)標(biāo)記在圖表下方,所有的時(shí)間步進(jìn)集中設(shè)在機(jī)械錯(cuò)誤范圍。
還可估計(jì)引線架插入沖模墊縫隙時(shí)不同表示方法對(duì)建模結(jié)果的影響。下面的圖表是封裝模型及其周圍銅帶的平面圖。如圖所示,沖模墊的一角通過連接桿與封裝體的一角相連。我們用兩個(gè)棱柱實(shí)現(xiàn)這種精確的空隙構(gòu)形。
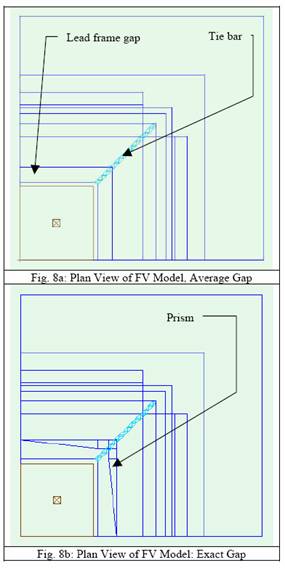
4.2 實(shí)驗(yàn)結(jié)果
用于每個(gè)DCP結(jié)構(gòu)的模型總功率值如下表所示:
表2 :用于FV分析的功率
|
DCP 結(jié)構(gòu) |
模型總功率 |
|
DCP-1 |
6.3 |
|
DCP-2 |
3.7 |
|
DCP-3 |
3.9 |
|
DCP-4 |
1.8 |
初始條件的溫度統(tǒng)一為25攝氏度。用熱阻尼來表示實(shí)驗(yàn)結(jié)果,因而功率的變化基本不會(huì)產(chǎn)生影響。Infineon在用FE為所有DCP構(gòu)型建模時(shí)所用功率均為5瓦。在由DCP-1至DCP-3的建模中,以熱傳遞系數(shù)10000W/m(2)K來表示底座與冷卻臺(tái)接觸面的熱傳遞性能,并假定冷卻臺(tái)溫度為25攝氏度。在DCP-1和DCP-3中,底座的油膜厚度為5µm ;DCP-2中底座的油膜厚度為20µm。
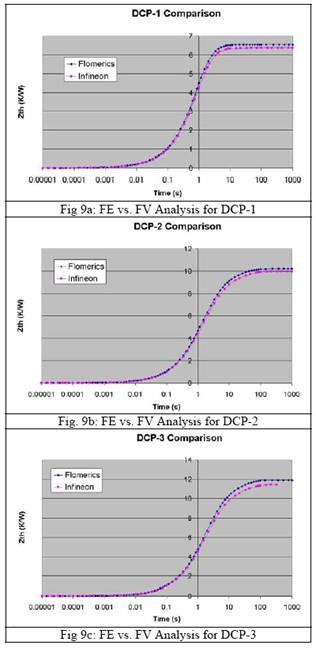
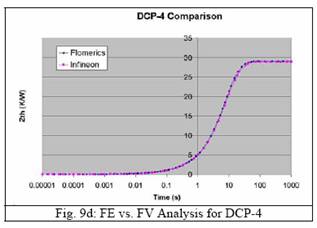
在DCP-4中,銅片底部的熱傳遞系數(shù)為10000W/m(2)K,它表示銅片底部與下層冷卻臺(tái)接觸面的熱傳遞性能。這一結(jié)構(gòu)中,我們將油膜的影響結(jié)合在銅片下部的熱傳遞系數(shù)中,不作單獨(dú)考慮。一層厚為10µm的油膜相當(dāng)于熱傳遞系數(shù)14000 W/m(2)K。
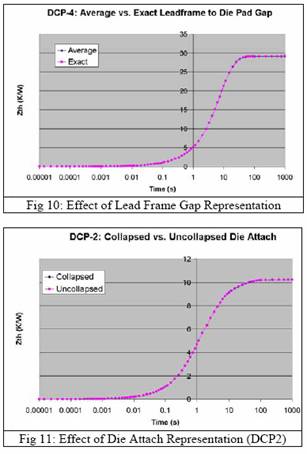
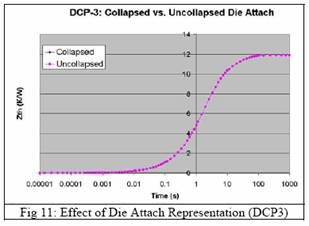
4.3 結(jié)果分析
圖10和11的顯示結(jié)果表明晶片粘附層厚度和引線架縫隙對(duì)模型幾乎沒有影響,它與我們所作的基本分析的結(jié)果是一致的。圖9d顯示,DCP-4中兩條曲線的吻合性很好,引線的熱量基本被去除。圖9a至9c對(duì)DCP-1至DCP-3的描繪顯示吻合性比較不好。由于基礎(chǔ)研究認(rèn)為出現(xiàn)這種情況不是在FV模型中使用假設(shè)條件建模造成的,因此這種差異很可能是兩種模型其他方面的不同所至。最顯著的不同是它們的連接桿的幾何表示不同。在FE模型中它有正確的表述,即由沖膜墊一角引出斜向插入引線架齒合面。而在FV模型中,連接桿只是簡(jiǎn)單的從沖膜墊一角伸出與引線架相連,如圖7b所示,而不是斜向連接。然而,對(duì)比FV模型中詳盡的連接桿描述,我們將此作為一種矛盾因素,有待進(jìn)一步的研究。但是,有一點(diǎn)應(yīng)該很清楚那就是兩種模型(FV和FE)的差異要小于不同物理部件的差別。
總結(jié)
在為芯片建立詳盡的熱封裝模型時(shí),通常用于穩(wěn)態(tài)的假設(shè)條件,如今在暫態(tài)領(lǐng)域里也得到了很好的應(yīng)用。這一結(jié)論對(duì)承擔(dān)板級(jí)和系統(tǒng)級(jí)暫態(tài)設(shè)計(jì)的工程師來說是非常重要的,同時(shí)對(duì)創(chuàng)建暫態(tài)熱壓縮模型的工程師也是十分重要的。
標(biāo)簽: 點(diǎn)擊: 評(píng)論: