半導(dǎo)體集成度的持續(xù)提升意味著需要在更小空間內(nèi)完成更多工作,這反過來會產(chǎn)生更多需要散逸的熱量。在先進(jìn)制程芯片和多芯片組件中,散熱管理對其功能穩(wěn)定性和使用壽命至關(guān)重要。盡管業(yè)界已將大量精力投入到提升電源效率(以降低功耗增長速率),但僅靠這一點(diǎn)遠(yuǎn)遠(yuǎn)不夠。我們還需要多種技術(shù)來推動熱量向上、向下及向外傳導(dǎo)。值得慶幸的是,多個領(lǐng)域已取得顯著進(jìn)展。
01 更多運(yùn)算帶來更多熱量
電路執(zhí)行運(yùn)算所需的能量來自電源引腳,但并非所有能量都會轉(zhuǎn)化為有效運(yùn)算功 —— 部分能量會以熱量形式損耗,這些熱量必須從源頭移除并釋放到環(huán)境中。對于成功的芯片設(shè)計,散熱速率必須與能量消耗速率達(dá)成平衡。但除了功耗之外,芯片內(nèi)熱量產(chǎn)生的區(qū)域面積也需納入考量:面積越小,功率密度越高,對冷卻策略的要求就越嚴(yán)苛。Promex 首席運(yùn)營官 Dave Fromm 表示:“關(guān)鍵在于嘗試從幾平方厘米的區(qū)域中散除瓦特級熱量,單位面積的功率密度已達(dá)到驚人的程度。”
硅芯片的最大尺寸受限于光刻掩模版(26×33 毫米),但封裝尺寸并無此類上限。不過封裝尺寸無法任意設(shè)計,部分原因在于業(yè)界尚未大規(guī)模需求此類大尺寸封裝,生產(chǎn)線也未為此做好設(shè)備適配。盡管如此,更大的封裝尺寸可進(jìn)一步分散熱量,降低功率密度。
Kelly 觀察到:“我們并非將所有芯片內(nèi)容塞進(jìn)固定尺寸的封裝中,封裝尺寸在逐步增大,這使得功率密度可能保持穩(wěn)定或緩慢增長。這與硅芯片不同,后者受限于掩模版尺寸。”
然而,更大的封裝可能更易發(fā)生翹曲。Amkor 芯片粒 / FCBGA 開發(fā)高級總監(jiān) YoungDo Kweon 表示:“目前常見的封裝尺寸為 60×60 平方毫米,Amkor 已量產(chǎn) 85×85 平方毫米的封裝。未來幾年,我們將推出超過 100×100 平方毫米的封裝,這意味著熱應(yīng)力可能顯著增加。”材料的熱導(dǎo)率以 W/Km衡量,熱傳導(dǎo)路徑越短,熱導(dǎo)率越高。因此,路徑中的材料越薄越好。
02 熱量在封裝中的傳導(dǎo)路徑
熱量主要在有源硅層中產(chǎn)生。在倒裝芯片封裝中,熱量可向上傳導(dǎo) —— 通過體硅至芯片背面并散出封裝;也可向下通過各類金屬連接端傳導(dǎo)至印刷電路板(PCB),某些情況下還可能橫向傳導(dǎo),具體取決于應(yīng)用場景。
Kelly 表示:“以筆記本電腦為例,其散熱路徑包括芯片背面和主板另一側(cè);但對于數(shù)據(jù)中心和高性能設(shè)備,通過電路板向下的熱傳導(dǎo)路徑電阻極高,因此 95% 以上的熱量會從頂部散出。”
多年來,帶內(nèi)置風(fēng)扇的散熱片一直是高功率封裝的標(biāo)準(zhǔn)配置。散熱片由銅或鋁制成,金屬材料的選擇取決于散熱片后的熱傳導(dǎo)路徑。
鋁從封裝吸收熱量時溫度上升更快,這種顯著的溫度變化使熱交換效率更高。Fromm 指出:“對于相同尺寸的散熱片,改變銅的溫度比改變鋁的溫度更困難。”
若散熱片與空氣進(jìn)行熱交換,空氣必須保持流動 —— 因為空氣是極差的熱導(dǎo)體。若散熱片通過螺栓連接至其他導(dǎo)熱固體,則銅可能更為適用。銅的比熱容更高,意味著其可存儲更多熱量而溫度上升幅度小于鋁。因此,銅與空氣的熱交換效率較低,但當(dāng)連接至其他固體時,能高效將熱量傳導(dǎo)至后續(xù)散熱裝置。
若計算任務(wù)呈突發(fā)性(伴隨長時間空閑期),銅搭配風(fēng)扇也能發(fā)揮作用,因其有更多時間與空氣進(jìn)行熱交換。Fromm 表示:“若工作模式為短時間高強(qiáng)度脈沖 + 長時間停機(jī),銅在長期溫度緩沖方面表現(xiàn)更優(yōu),而鋁會瞬間升溫。”
03 熱點(diǎn)難題
芯片熱點(diǎn)帶來另一重挑戰(zhàn)。相較于為整個封裝配備足以同時處理所有熱點(diǎn)的散熱能力,熱擴(kuò)散器可在封裝內(nèi)平衡熱量分布。傳統(tǒng)金屬擴(kuò)散器位于封裝內(nèi)部,可為獨(dú)立金屬塊或與芯片形成熱連接的金屬外殼。
Kelly 表示:“實現(xiàn)高效熱擴(kuò)散的最佳方式是沿垂直方向高效散熱。若散熱效率足夠高,熱點(diǎn)將無法持續(xù)升溫并擴(kuò)散熱量。”
連接擴(kuò)散器及其他元件的技術(shù)是當(dāng)前研發(fā)重點(diǎn),這類材料被稱為熱界面材料(TIMs),其作用是確保兩表面間形成保形層。Fromm 解釋道:“理想情況下,TIM 應(yīng)像膠水一樣固定位置,但若無需支撐元件,也可使用油脂。關(guān)鍵在于消除空氣間隙 —— 理想的 TIM 材料需兼具固定性和應(yīng)力保形性。”
典型封裝可能包含兩種 TIM,有時稱為 TIM I和 TIM II。Kweon 表示:“封裝內(nèi)部存在兩個界面:一個是散熱片與熱擴(kuò)散器之間的界面,另一個是芯片背面與熱擴(kuò)散器之間的界面。”

圖 1:熱界面材料的兩種典型應(yīng)用。TIM I 位于芯片與熱擴(kuò)散器之間,TIM II 位于熱擴(kuò)散器(此例中為封裝外殼)與散熱片之間,箭頭指示散熱方向。來源:Amkor
04 金屬 TIM 的崛起
傳統(tǒng) TIM 主要由聚合物制成,但由于聚合物導(dǎo)熱性差,常需摻雜導(dǎo)電添加劑。Fromm 表示:“人們會向聚合物中摻入碳、石墨或各類高導(dǎo)電性金屬,金剛石是另一種開始被使用的填充材料,其熱活性可能比銅高 5 至 10 倍。”
即便如此,TIM 的導(dǎo)熱性仍相對較差,因此保持薄層可縮短熱傳導(dǎo)路徑。對于散熱需求約 100 瓦的封裝,傳統(tǒng) TIM 已足夠有效,但新型芯片和先進(jìn)封裝的散熱需求預(yù)計達(dá) 1000 瓦級別,這對現(xiàn)有材料提出了嚴(yán)峻挑戰(zhàn)。
金屬 TIM(尤其是銦合金)如今已具備更高熱導(dǎo)率。Amkor 發(fā)現(xiàn),改用銦合金可使芯片結(jié)溫降低超過 10°C。Kweon 指出:“使用聚合物 TIM 時,溫度每升高 10°C,芯片壽命通常減半。如今許多客戶要求功率超過 400 瓦的芯片使用金屬 TIM。”
TIM 受熱時的膨脹速率與附著材料不同,因此粘合劑可能比油脂承受更多熱應(yīng)力。這可能成為 Kweon 預(yù)計未來幾年推出的更大封裝面臨的問題。他表示:“這意味著若使用聚合物 TIM,芯片邊緣的拉伸應(yīng)力可能導(dǎo)致分層,使其無法正常工作。”

圖 2:采用金屬 TIM 的模塑 FCBGA。來源:Amkor
05 系統(tǒng)級散熱組件
空氣流動的冷卻能力有限,因此對于高要求的組件,液體正以多種形式應(yīng)用于散熱。用液體包圍封裝或子系統(tǒng)(沉浸式冷卻)可實現(xiàn)比空氣更高效的散熱。
Kelly 表示:“當(dāng)功率達(dá)到 800 至 1200 瓦(取決于封裝結(jié)構(gòu)),風(fēng)冷系統(tǒng)將無法滿足需求,必須轉(zhuǎn)向某種液體冷卻方式,使低溫液體與芯片直接接觸。”
這需要閉環(huán)系統(tǒng) —— 液體從發(fā)熱組件循環(huán)至換熱器,冷卻后返回。這也會增大芯片與冷卻溶液間的溫度梯度。Kelly 指出:“這會導(dǎo)致各處應(yīng)力升高,但好在 IC 封裝材料較 10 年前已大幅改進(jìn)。”
傳統(tǒng)液體冷卻僅依賴液態(tài)介質(zhì),而更先進(jìn)的技術(shù)則利用液 - 氣兩相。Synopsys 高級工程師 Satya Karimajji 表示:“最先進(jìn)的冷卻方法是兩相沸騰流。”
沉浸式冷卻將液體冷卻推向新高度 —— 將整個系統(tǒng)浸入流動液體中,其散熱效率遠(yuǎn)超其他技術(shù)。然而,由于系統(tǒng)必須密封以容納液體,其結(jié)構(gòu)復(fù)雜且成本高昂。當(dāng)前研究重點(diǎn)是尋找最高效的液體介質(zhì)。Karimajji 表示:“研究人員正在探索可使用的各類介電流體和制冷劑。”
06 空間受限場景的散熱方案
液/氣冷卻技術(shù)還體現(xiàn)在兩種不同方案中。蒸汽腔雖非新技術(shù),但作為散熱手段正愈發(fā)流行。Kweon 表示:“如今許多客戶正轉(zhuǎn)向在封裝頂部配備冷板的蒸汽腔方案。”
蒸汽腔以密封腔體取代金屬塊,腔內(nèi)含蒸汽,一側(cè)接觸芯片,另一側(cè)接觸冷卻板。這類兩相系統(tǒng)中,熱源作為蒸發(fā)器,冷端作為冷凝器,內(nèi)部通常包含某種吸液芯材料,用于將冷凝液送回蒸發(fā)器。
Karimajji 表示:“假設(shè)熱量集中在小區(qū)域,而我們希望將熱量擴(kuò)散至更大區(qū)域,[蒸汽腔] 可增強(qiáng)散熱片基座的溫度均勻性。”
在筆記本電腦和手機(jī)等缺乏散熱片空間的系統(tǒng)中,熱管可將熱量從熱源傳導(dǎo)至更遠(yuǎn)位置。冷凝液通過毛細(xì)作用流向蒸發(fā)器,推動蒸汽從另一側(cè)流動,系統(tǒng)依靠產(chǎn)生的熱量驅(qū)動。
Karimajji 舉例:“若筆記本電腦的 CPU 附近無足夠空間安裝風(fēng)扇,可通過熱管將 CPU 頂部的熱量傳導(dǎo)至筆記本邊緣,再在邊緣安裝風(fēng)扇。優(yōu)勢在于無需泵體。”
盡管冷卻能力適中,熱管的最大優(yōu)勢在于尺寸。Karimajji 指出:“僅靠熱管可能不足以冷卻 GPU。” 這類結(jié)構(gòu)中使用的液體通常為去離子水,但根據(jù)工作溫度也可使用制冷劑。
07 封裝蓋的取舍
封裝蓋可為內(nèi)部組件提供保護(hù)和機(jī)械穩(wěn)定性,但暴露芯片背面則為不同冷卻技術(shù)創(chuàng)造了可能。
Kelly 表示:“封裝蓋有助于散熱,從而提升整體散熱性能;此外,在測試過程中,封裝蓋作為保護(hù)結(jié)構(gòu)至關(guān)重要 —— 功能測試或系統(tǒng)級測試的機(jī)械插拔過程非常嚴(yán)苛,因此使用封裝蓋的客戶很看重這一點(diǎn)。無封裝蓋時,客戶始終會擔(dān)心測試中的機(jī)械完整性。”
一種正在研發(fā)的冷卻技術(shù)是水沖擊冷卻 —— 直接向無蓋芯片的背面噴射水流。
Kelly 解釋:“直接向硅片頂部噴水,比將水容納在某種水套中能散除更多熱量。水不發(fā)生相變,但硅片表面的水邊界層變得極薄,因此熱阻極低。”
對于無封裝蓋支撐的芯片,可在基板邊緣放置環(huán)形加強(qiáng)件,以提供剛度并緩解溫度變化導(dǎo)致的翹曲。
更前沿的技術(shù)是微流控散熱,即通過內(nèi)部微通道使冷卻劑流動。液體不再僅包圍封裝,而是流經(jīng)通道并從內(nèi)部吸收熱量。
Karimajji 描述:“微尺度散熱片包含兩部分:一部分位于 CPU 模塊頂部,另一部分是帶風(fēng)扇的散熱片,兩者通過液體回路連接。液體流經(jīng) CPU 模塊吸熱,然后進(jìn)入稱為‘散熱器’的冷卻槽,散熱片在此處將熱量釋放到環(huán)境中,冷流體再被泵回 CPU 模塊。”
這對硅片堆疊的冷卻尤為重要 —— 堆疊頂部的芯片可輕松向環(huán)境散熱,而中間的芯片必須通過堆疊傳導(dǎo)熱量。微通道為中間芯片提供了更高效的散熱路徑,代價是系統(tǒng)復(fù)雜度和成本的上升。
目前這些系統(tǒng)主要為單相散熱。Karimajji 補(bǔ)充:“業(yè)界正嘗試將兩相系統(tǒng)從研發(fā)階段推向商用。”
08 熱量向 PCB 傳導(dǎo)的路徑
熱量向 PCB 及系統(tǒng)其他部分傳導(dǎo)的路徑更為復(fù)雜。自然散熱路徑包括芯片與基板的界面(即芯片黏接層)以及從芯片延伸至 PCB 連接端的金屬引線。
在先進(jìn)封裝中,并非所有引線都延伸至封裝外部:內(nèi)部信號引線在封裝內(nèi)組件間傳遞熱量,而外部引線可能需先經(jīng)過中介層或硅橋才能到達(dá)基板。
Karimajji 表示:“中介層可達(dá)六層,但若仍不足,從封裝頂部散熱是另一種并行路徑。”
更高導(dǎo)熱性的共晶合金可改善芯片黏接層的熱傳導(dǎo),引線也發(fā)揮重要作用。
Fromm 指出:“金屬密度有助于散熱,接地連接和平面層對此有益。然而,若芯片的高互連區(qū)域正是熱源,則其成為凈熱原而非散熱端。”
Synopsys 產(chǎn)品管理總監(jiān) Keith Lanier 表示:“芯片最高溫度取決于 [互連] 凸點(diǎn)的密度。使用 EDA 優(yōu)化工具可調(diào)整凸點(diǎn)密度,從而影響芯片最高溫度。”
09 新型焊料與基板
焊料類型同樣關(guān)鍵,金錫焊料在這方面表現(xiàn)優(yōu)異。Fromm 表示:“標(biāo)準(zhǔn)焊料的熱導(dǎo)率約為 20-30 W/mK,金錫焊料約為 60 W/mK,性能提升三倍。”
燒結(jié)銀也受到關(guān)注,尤其在功率器件領(lǐng)域。Fromm 介紹:“這類材料為膏狀,像環(huán)氧樹脂一樣涂覆,燒結(jié)后熱導(dǎo)率極高 —— 可達(dá) 70-100 甚至 150 W/mK。”
據(jù) Kweon 透露,Amkor 也在研發(fā)銅引線連接技術(shù),但銅材料加工難度更高,需更精細(xì)的工藝控制,導(dǎo)致成本上升。Fromm 表示:“銅連接可行,但表面必須極潔凈且氧化層需嚴(yán)格控制,因此需在惰性氣氛中操作。這與銅基芯片間混合鍵合面臨的挑戰(zhàn)類似。”
無論通過引線還是芯片黏接層,所有潛在散熱路徑在到達(dá) PCB 前都需經(jīng)過基板。標(biāo)準(zhǔn)有機(jī)基板的導(dǎo)熱性一般,但未來可能出現(xiàn)更高熱導(dǎo)率的陶瓷基板。
Fromm 表示:“在我看來,理想方案是高密度、高導(dǎo)熱性陶瓷基板,既能散熱又能提供足夠的 I/O 密度。”
此類基板成本將高于有機(jī)基板,但其比有機(jī)基板更平整、更堅硬,可提升生產(chǎn)良率。Fromm 推測:“或許組裝良率將推動經(jīng)濟(jì)平衡 —— 即使基板成本更高,若能以更高良率制造或獲得更高性能,可能仍具性價比。”
10 側(cè)向散熱路徑
從芯片側(cè)面散熱為冷卻增加了新路徑。盡管單個芯片可能因過薄而效果有限,但芯片堆疊可通過側(cè)向路徑散熱,且無需承擔(dān)微流控技術(shù)的成本與復(fù)雜度。一種方法是模塑倒裝芯片球柵陣列(FCBGA)。
在標(biāo)準(zhǔn) FCBGA 中,組件周圍是空氣;而模塑 FCBGA 中,該空間填充導(dǎo)熱模塑化合物,使熱量可從堆疊中的芯片側(cè)向傳導(dǎo)。
Kweon 解釋:“在芯片堆疊中,被夾在中間的芯片缺乏有效散熱路徑,因為封裝內(nèi)芯片周圍的空氣是極差的熱導(dǎo)體。” 模塑材料取代空氣,改善了側(cè)向熱傳導(dǎo)路徑。
隨著先進(jìn)硅制程應(yīng)力的增加,這一技術(shù)愈發(fā)重要。Kweon 補(bǔ)充:“硅制程即將進(jìn)入 2nm,此時層間電介質(zhì)非常脆,模塑 FCBGA 可降低熱應(yīng)力屏障。”
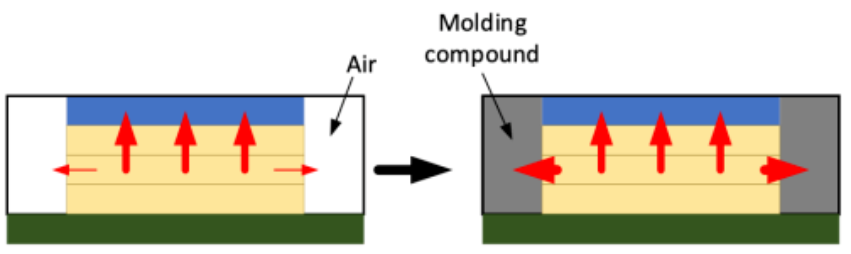
圖 3:模塑 FCBGA。模塑材料取代封裝內(nèi)的空氣,改善側(cè)向散熱路徑。來源:Bryon Moyer
11 多元化散熱方案的演進(jìn)
隨著芯片和封裝產(chǎn)熱持續(xù)增加,散熱方案的數(shù)量也在不斷增長。鑒于封裝內(nèi)組件間的復(fù)雜相互作用,組裝技術(shù)的變革往往是漸進(jìn)式的。即便存在革命性新系統(tǒng),也不太可能完全取代現(xiàn)有方案 —— 因此,我們所見的各類技術(shù)將以不同組合持續(xù)演進(jìn)。
早期設(shè)計規(guī)劃至關(guān)重要。Synopsys SoC 工程高級總監(jiān) Shawn Nikoukary 表示:“我們確實看到更多前期工作,包括架構(gòu)探索甚至 RTL 層級的優(yōu)化。我們必須影響芯片架構(gòu)以實現(xiàn)最佳散熱性能,架構(gòu)階段投入越多,后期工作就越輕松。”
同時,不應(yīng)忽視應(yīng)用場景決定的成本上限。Kelly 指出:“數(shù)據(jù)中心傾向于采用相當(dāng)前沿的解決方案,因其市場更能承擔(dān)成本;但對于筆記本、臺式機(jī)或其他邊緣設(shè)備,我們必須謹(jǐn)慎控制成本并高效散熱。”

標(biāo)簽: 芯片元器件 點(diǎn)擊: 評論:
