本文首先創(chuàng)建了 SiC 雙面散熱功率模塊的有限元模型,并對網(wǎng)格劃分的結果進行了 收斂性分析,驗證了網(wǎng)格劃分的正確性。基于以上模型對封裝結構的傳熱性能進行穩(wěn)態(tài)分析,通過對不同封裝材料的功率模塊進行瞬態(tài)分析得出模型應使用的較佳材料,最終研究了燒結銀焊層厚度對功率模塊結溫的影響,為 SiC 雙面散熱功率模塊的設計提供了參考。 近年來,以碳化硅(Silicon Carbide, SiC)器件為代表的第三代功率半導體技術在電動/混動汽車、新能源發(fā)電、5G 通信裝備以及航空航天等微系統(tǒng)封裝集成應用方面呈現(xiàn) 出巨大的潛在應用價值和前景。發(fā)展針對 SiC 器件工作特點的模塊封裝技術已經(jīng)成為電 子封裝領域的重要研究課題和產(chǎn)業(yè)界的迫切需求。 由于各種材料的限制,硅基功率器件在許多方面已經(jīng)達到其材料的理論極限,目前所存在的功率模塊封裝技術大部分都是 為硅基功率模塊設計,將其直接應用于 SiC 功率模塊,會出現(xiàn)使用頻率、散熱、可靠性等多方面帶來的新挑戰(zhàn)。本文從熱角度分析 SiC 技術設計方案的關鍵影響因素,這為發(fā)展針對 SiC 器件工作特點的高可靠互連封裝技術提供參考依據(jù)。 2.1 SiC 雙面散熱功率模塊模型假設和簡化 雙面散熱功率模塊的主要結構包括 SiC 芯片、二極管芯片、燒結銀焊層、DBC 基 板(包括上銅層、氮化鋁陶瓷層與下銅層)、陶瓷層及填充介電層,功率模塊實際示意 圖如圖 1 所示。對模型進行假設和簡化:功率模塊中的各層材料和結構均為各向同性的均勻層狀結構;忽略外殼模型的建立;仿真建模時只建立了包含單個 SiC 芯片和單個二極管的有限元模型;對芯片與二極管之間的鋁鍵合線等進行了省略,只對整個模型的 一半進行構建,對模型進行切分并賦予材料。 圖1 雙面散熱功率模塊實際示意圖 2.2 SiC 雙面散熱功率模塊有限元模型的網(wǎng)格劃分與收斂性分析 單元類型為 Thermal Solid 8node 70 單元。在芯片和燒結銀焊層位置適當?shù)膶⒕W(wǎng)格單 元密度增大,其余位置適當降低網(wǎng)格密度。為了保證結果的準確性,需對模型的網(wǎng)格進 行相應的收斂性驗證。共使用了 8 種不同的網(wǎng)格尺寸進行加密,對有限元模塊穩(wěn)態(tài)結溫進行對比,如圖 2 所示。當網(wǎng)格數(shù)量達到 30 萬時,有限元仿真得到的模塊結溫已經(jīng)趨近于收斂。因此有限元仿真計算中模型的網(wǎng)格數(shù)量盡量保持在 30 萬以上。 圖2 網(wǎng)格劃分收斂性分析 2.3 雙面散熱功率模塊的熱分析載荷及邊界條件 仿真中 SiC 芯片發(fā)熱功率為 100W,使用體熱生成載荷施加在 SiC 芯片上,體熱 流密度為 21367mW/mm3。SiC 模塊上下兩底部與水冷之間進行強制換熱,其環(huán)境溫度 為 45℃,對流換熱系數(shù)設置為 3mW/(mm2 ?K),對稱面采取相對絕熱狀態(tài),不設置對流 換熱,其余裸露在空氣中的模塊表面與空氣進行對流換熱,環(huán)境溫度設置為 25℃,其對 流換熱系數(shù)設置為 0.01mW/(mm2 ?K)。添加載荷及邊界條件的有限元模型如圖 3 所示。 圖 3 功率模塊載荷及邊界條件 通過對 SiC 雙面散熱功率模塊有限元仿真的穩(wěn)態(tài)結果進行分析,得出穩(wěn)態(tài)溫度為 155.933℃,仿真穩(wěn)態(tài)結果如圖 4 所示。由圖中溫度分布可知,SiC 芯片一側的溫度大于 二極管一側的溫度,且呈軸對稱分布,這是由于模型載荷作用于 SiC 芯片上,且模型構 建時只建立了整體模型的一半。距離芯片越遠處,溫度越低。由穩(wěn)態(tài)數(shù)據(jù)可以發(fā)現(xiàn)最高溫度節(jié)點的編號為 155891 號節(jié)點,瞬態(tài)仿真基于最高溫度的節(jié)點進行。 圖 4 雙面散熱功率模塊穩(wěn)態(tài)結果 通過對二氧化硅與環(huán)氧樹脂分別作為填充層時的功率模塊進行有限元仿真,瞬態(tài)對比圖如圖 5 所示,由瞬態(tài)結果分析可知,環(huán)氧樹脂作為填充層比 SiO2 作為填充層升溫 速率快,但穩(wěn)態(tài)結溫高 0.016℃,這是因為仿真時使用的環(huán)氧樹脂的熱導率比 SiO2 的熱導率低,熱導率越低,會使模塊穩(wěn)態(tài)結溫越高。 圖 5 不同填充層瞬態(tài)分析對比圖 通過對不同焊料層的材料參數(shù)進行仿真,對比圖如圖 6 所示,由瞬態(tài)結果分析可知 燒結銀的傳熱能力比 SnPb、SnAg25Sb10、SAC305、Ag 這四種材料的傳熱能力更強,由分析可知,燒結銀材料較適合作為焊料層。 圖 6 不同焊料層瞬態(tài)對比圖 通過對不同 DBC 基板陶瓷層的材料進行瞬態(tài)分析,對比圖如圖 7 所示,由瞬態(tài)分 析結果可知,氮化鋁作為材料比氧化鋁作為材料的模塊穩(wěn)態(tài)結溫低了 10.339℃,使用氧 化鈹作為材料比氮化鋁作為材料的模塊穩(wěn)態(tài)結溫低了 2.108℃,但氧化鈹在加工過程中 對人體有害。由分析可知,氮化鋁更適合作為 DBC 基板的陶瓷層材料。 圖 7 不同陶瓷層瞬態(tài)對比圖 在 DBC 基板的陶瓷層使用氮化鋁,焊料層使用燒結銀,填充層使用環(huán)氧樹脂的模型中,更改燒結銀焊層的厚度,針對 5 種不同厚度的燒結銀有限元模型進行了穩(wěn)態(tài)分析。不同燒結銀厚度對應的模塊穩(wěn)態(tài)結溫對比如圖 8 所示,分析得到模塊的穩(wěn)態(tài)結溫與燒結銀的厚度呈線性關系。 圖 8 不同燒結銀厚度的結溫對比 本文通過傳熱分析研究了雙面散熱有限元模型的穩(wěn)態(tài)溫度場,得到了在特定載荷下 的模塊結溫為 155.933℃,通過對不同填充層、不同焊料層、不同陶瓷基板層進行穩(wěn)態(tài)和瞬態(tài)分析,得出較佳的使用材料。在此基礎上,通過改變燒結銀的厚度對功率模塊進行穩(wěn)態(tài)分析,得到雙面散熱功率模塊的穩(wěn)態(tài)結溫與燒結銀的厚度呈線性關系。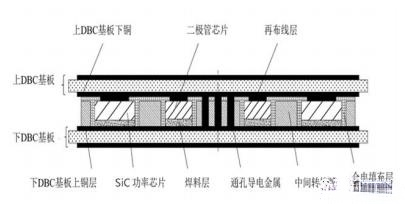



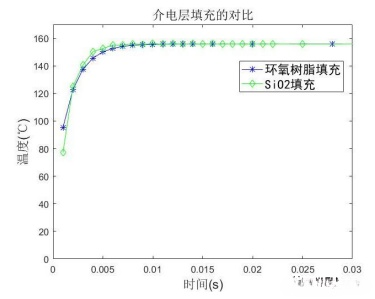

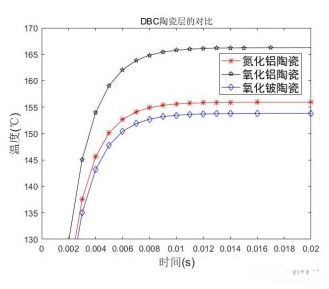

SiC 雙面散熱封裝結構傳熱性能分析
熱設計
版權聲明:除非特別標注,否則均為本站原創(chuàng)文章,轉載時請以鏈接形式注明文章出處。
